結晶粒径の制御によるハイブリッド接合技術(開発中)
総合研究所 CS電子技術部 曽根 絵理子 Eriko SONE 佐波 正浩 Masahiro SAWA
はじめに
半導体パッケージは、多端子化と小型化薄型化の要求に応える形で発展してきた。さらなる高性能化を目的として、仕様の異なるデバイスや異種デバイスなどを1つのパッケージに実装するシステムインパッケージ(System in Package:以下、SiP)が開発されている。SiPには、微細配線を形成した有機基板を使用する2.1D SiPや2.3D SiP、Through Silicon Via(TSV)を配したシリコンインターポーザを有する2.5D SiP、TSVを有するデバイス同士をマイクロバンプやハイブリッド接合で接続する3D SiPなどが提案されている。ハイブリッド接合とは、マイクロバンプを使用せずCuパッドやその周辺のSiO₂を直接接合させる技術であり、産学で研究が進められている。
われわれは、電気めっきによって析出するCuの結晶粒径を制御し、物理的性質に優れる粗大Cu結晶粒の作製に成功した。さらに、このCuを用いたCu-Cu間拡散接合技術を開発した。また、デイジーチェーンによりピッチ8 μmで形成したハイブリッド接合の電気的接続を確認したので、これらの実験結果について述べる。
特長
- 結晶粒径の制御が可能
- 高い接合強度が得られる
- 電気特性に優れる
実験1 結晶粒径と物理的性質
ステンレス板を被めっき物として、硫酸銅五水和物と硫酸からなる硫酸銅めっきの基礎液に、添加剤としてブライトナーやレベラーと呼ばれる有機化合物と塩化物イオンを添加し、電気めっきを行った。Cuを60μm析出させた後、ステンレス板からCuを剥離することでCu箔を作製した。レベラーには熱処理後に、結晶粒径が大きく異なる二種類の化合物を選定した。結晶成長の緩やかなレベラーを含有させた液をめっき液A、結晶成長の顕著なレベラーを含有させた液をめっき液Bとした。得られた二種類のCuを熱処理し、集束イオンビーム試料作製装置(FIB)で加工した断面からSIM像により結晶粒径を評価した。FIBにより加工したCuの断面SIM像を図1に示す。
めっき液Aで析出させたCuは2μm以下の粒径であるが、めっき液Bで析出させたCuは5μm以上の粒径を多数観察し、粗大Cu結晶粒の存在を確認した。
電気的特性は、誘電体共振器法によりマイクロ波帯のCu箔表面比導電率を測定した。熱伝導率は、水中置換法により密度、DSC法により比熱、光交流法により熱拡散率を測定することで算出した。電気伝導率の結果を図2に、熱伝導率の結果を表1に示す。めっき液Bで作製した粗大Cu結晶粒を有するCuは電気伝導率、熱伝導率に優れることを確認した。
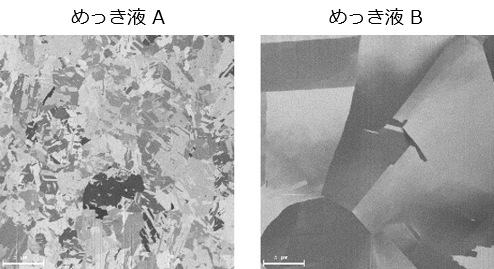


実験2 ハイブリッド接合
接合と接続信頼性の評価に用いたデイジーチェーンTEGウエハは、300mmウエハに、Cu電極幅5μm、ピッチ8、10、12 μmとし、絶縁層にはプラズマTEOS-CVDにより形成したSiO₂を採用した。接合には、Chip-to-Wafer用フリップチップボンダーを用いた。また、ソーダイシングで上部チップサイズを6mm角に個片化した。Chip-to-Waferの接合は、チップをクエン酸で洗浄後、Arプラズマで表面処理し、大気圧中、フリップチップボンダーで仮接合した後、N₂雰囲気下で熱処理し本接合を行った。
めっき液Aおよびめっき液Bで、TEGウエハにCuを析出させて二種類のウエハを作製した。それぞれのめっき液で析出したCu同士を接合させ、界面の結晶状態を後方散乱電子回析(EBSD)により評価した。EBSDにより得られた断面の結晶方位を図3に示す。めっき液Aで析出させたCu-Cu間の接合界面では、粒径が細かく、さまざまな配向が混在している。また、上下のCuの結晶方位はほとんど揃っていない。一方、めっき液Bで析出させたCuの接合界面では、粒径が大きく、上下のCuの結晶方位が類似している。
図4はめっき液Bで析出させたCuを電極幅5μm、ピッチ8 μmのTEGウエハを用いてハイブリッド接合した断面SIM像である。図5に示すように、デイジーチェーンの接続抵抗においては、電流と電圧が線形関係であるとともに、チェーンの段数に比例して抵抗が増大する傾向を確認した。計算から得た理論抵抗と比較しても同等の値が得られていることから、酸化銅の存在やディッシングの影響は認められず、SiO₂同士が常温で接合した後、熱処理によって膨張とともに結晶粒成長したCu同士が電気的に接続したと考えられる。
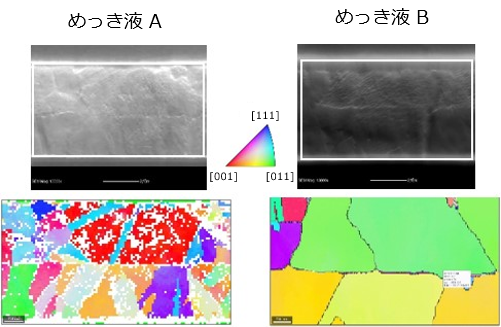
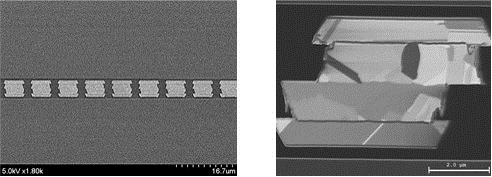

おわりに
添加剤の選定や電気めっき条件の最適化により、粗大Cu結晶粒の作製に成功した。粗大Cu結晶粒は優れた電気伝導率と熱伝導率を示した。Cuは多結晶であり、各結晶粒はある方位の結晶軸をもつことから、その障壁の少ない粗大Cu結晶粒は配線材料に好適であると考えられる。さらに、粗大Cu結晶粒をハイブリッド接合に応用することで、接合界面の配向を整合させ、非常に低い電気抵抗を導き出すことができた。
電気Cuめっきによる配線形成技術は、電子機器の発展に大きく貢献してきた。しかしながら、持続可能な社会の実現に向けて、省エネルギ化、省資源化を達成するため、電子機器にはさらなる高性能化、高機能化、小型化、軽量化が求められている。本技術がこれらの課題解決に貢献できるよう今後も鋭意研究に努める。
謝辞
本研究は東北大学およびGlobal INTegration Initiative(GINTI)との共同研究です。ご指導、ご鞭撻をいただきました。東北大学福島准教授、Murugesan Mariapppan博士に、心より厚く御礼申し上げます。




