チタン/銅スパッタシード層一括エッチングプロセス TIPHARES TCE
総合研究所 電子技術開発部 馬 恒怡 Hengyi MA 泉谷 美代子 Miyoko IZUMITANI 文蔵 隆志 Takashi FUMIKURA
はじめに
次世代半導体の製造に必要とされるAdvanced Packageの分野では、基板分野で用いられる無電解めっき法によるCuシード層ではなく、スパッタ法により成膜したTiおよびCuシード層が使われることが多い。これは層間絶縁材を粗化させずとも高い密着性が得られ、薄膜かつ平滑にシード層を形成でき、微細配線の形成に有利なためである。
しかしながら、シード層が異なる2種の金属による2層構造からなるため、エッチング工程もCuシード層とTiシード層のエッチングを別々に行う必要がある。また、従来Tiシード層をエッチングするためには、フッ化水素酸等のフッ化物やpH調整をした高濃度の過酸化水素を用いるため、作業環境などへの配慮が必要となる。
上記の課題を踏まえ、当社では1工程でTiとCuのシード層を除去可能であり、かつフッ化物や高濃度過酸化水素を使用しないシード層エッチングプロセスTIPHARES TCE(以下 TCE)の開発に至った。本稿ではTCEのエッチング性能について紹介する。
特長
- Ti/Cuスパッタシード層の一括除去が可能
- シード層エッチング後、良好な配線形状を維持
- フッ化物非含有のため、環境への負荷低減が可能
TCE性能について
1.配線断面形状
層間絶縁材上にスパッタ法によりTiおよびCuシード層を成膜し、めっきでCu配線を形成した基材を試験基材として用いた。エッチング処理前後の配線断面像を図1に示す。エッチング前の状態と比較し、配線形状の大幅な変化はみられず、良好な形状を保ったまま、シード層が除去されていることを確認できた。L/S=2/2μmの微細な配線においても、配線剥離が生じることなく、エッチングが可能であった。さらに、配線の裾部分の状態を確認した拡大写真を図2に示す。2層のシード層を一括でエッチングする際に金属種の違いからエッチング速度差が生じることで、配線細りやアンダーカットの発生が懸念されるが、TCEにおいてはTiシード層、Cuシード層とも過不足なくエッチングされており、配線剥離の原因となるアンダーカットが生じていないことが確認された。
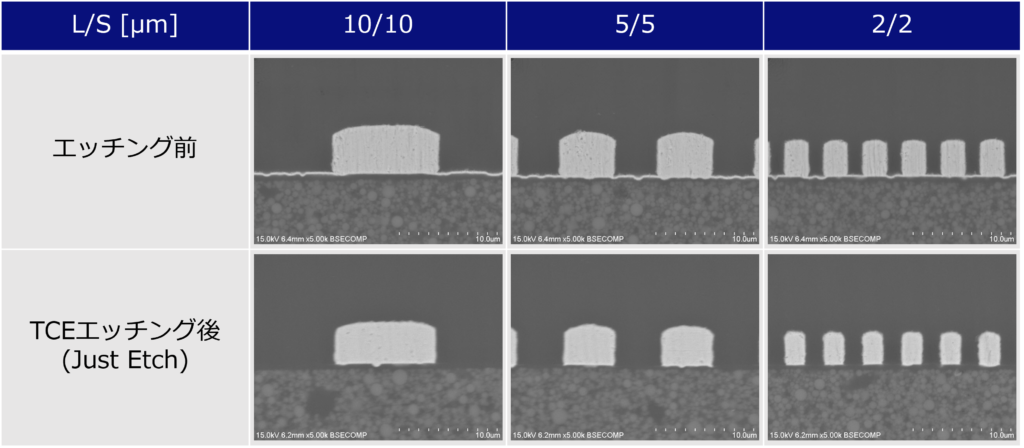

2.配線表面形状
TCEはシード層エッチング後の配線表面の粗さ変化が少なく、平滑性を維持することが可能である。図3にエッチング前後の配線表面状態の比較を示す。外観としてほぼ変化がみられておらず、粗さの指標としての二乗平均平方根高さ(Rq)測定値もほとんど変化しないことが確認できた。エッチング後も配線表面が平滑であることから、高周波帯での伝送損失の低減にも期待ができる。
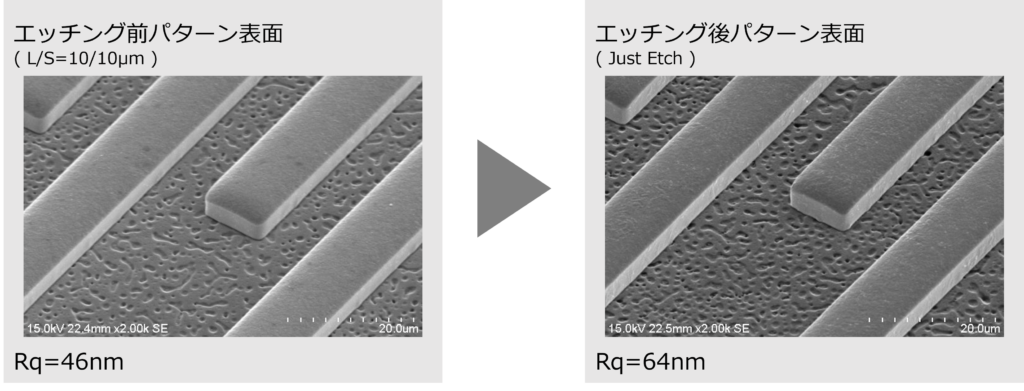
おわりに
本稿で紹介したTIPHARES TCEは、Ti/Cuスパッタシード層の一括除去および良好な配線形状を形成可能なプロセスである。また、従来のエッチング薬品よりも作業環境に配慮した製品である。今後も広がりをみせるAdvanced Package分野の発展に貢献できることを期待している。




