高面均THフィリングプロセスのご紹介 CU-BRITE TF8
総合研究所 電子技術開発部 江田 哲朗 Tetsuro EDA
JCU KOREA CORPORATION 岸本 一喜 Kazuki KISHIMOTO
はじめに
MSAP(Modified Semi Additive Process)工法は主にモバイル機器等のFC-CSP(Flip Chip-Chip Scale Package)基板の製造に用いられている。本工程は極薄銅箔付きの絶縁樹脂上の非回路部分に、ドライフィルムレジストを露光・現像し、シード層形成、硫酸銅めっきを行った後、エッチングにより微細回路を形成する。絶縁樹脂と銅箔の密着が取れている事と、極薄銅箔を少ないエッチング量で除去するため回路幅が減少しにくく、接続信頼性の高い微細な回路形成が可能となる。
課題
5Gの特性(高速・大容量・低遅延)を担保するため、電子デバイスに搭載される基板に対し、年々厳しい品質や規格を要求されるようになってきている。例えばミリ波などの高周波領域を使用するデバイス回路のインピーダンスの制御には、めっき膜厚バラつきの無い均一な回路形成が必要となる。また、BVHやX-Viaへの銅の充填(フィリング)については、BVHの凹みや盛り上がり形状が積層工程に影響を与えるため、めっき形状が厳しく規格化されている。加えて穴内にボイドと呼ばれる空隙が接続信頼性や放熱性の低下を招くためこれらにも対応する必要がある。しかし、上述のめっき膜厚の均一性とViaのフィリング性はトレードオフの関係にあり、これらに対応できる硫酸銅めっきプロセスとしてCU-BRITE TF8を開発したので報告する。
特長
- 優れたフィリング性能とパターン面内均一性能を両立
- 矩形性に優れた配線形状
- 様々なBVH/X-Viaへ適用可能
- 長期稼働においても優れた浴安定性を実現
BVHのフィリング性能と配線形状
図1に大径BVHへのフィリング性と配線形状を示す。大径BVHへのフィリング性能と良好な配線形状を確認した。
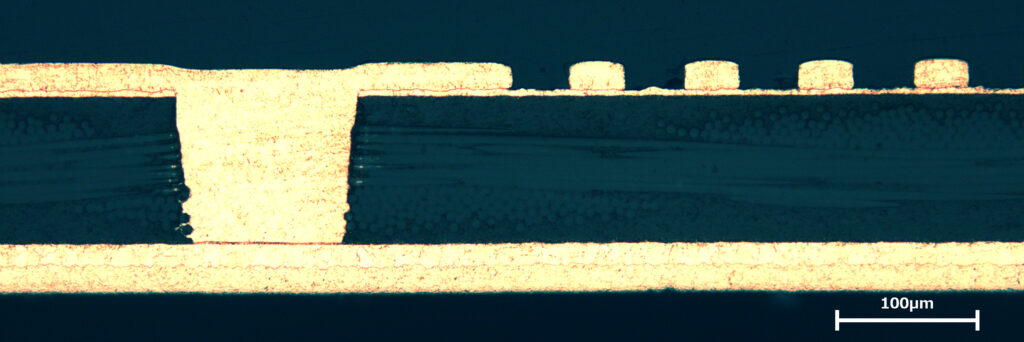
130μmφ‐100μmd, 1.5A/dm2‐20μm
X-Viaへのフィリング性能
図2に300μm厚みのX-Viaのフィリング性を示す。めっき条件および攪拌条件の最適化を行う事により、穴内のボイドが少ない良好なフィリング性能が得られている事を確認した。

90μmφ‐300μmt, 1.0A/dm2‐22μm
使用条件
下記に使用条件を示す。特殊な設備を必要とせずに既存設備を使用できる。

おわりに
CU-BRITE TF8は配線への高いパターン面内均一性と、BVHやX-Viaへの良好なフィリング性能を兼ね備える。今後も市場要求に応えるべく開発を続ける。




