回路形成(低粗度タイプ)エッチングプロセス FINE ETCH SACⅡシリーズ
CS技術統括部 電子技術部 畑中亮英 Ryoei HATANAKA
はじめに
2020年初頭より第5世代移動通信システム(5G)のサービスが世界的に始まっているが、5Gの特長のうち①多数同時接続、②データ伝送速度の超高速化、③超低遅延を実現するためには高周波に対応したプリント配線板が必要となる。
一般的なプリント配線板は、銅張積層板の銅箔が不要な部分をエッチングにより除去するサブトラクティブ法で製造されているが、配線幅の精度に限度があり、L/Sは30/30μm程度までと言われている。これより微細な配線は電気めっきを用いて形成され、代表的な工法の一つとしてSemi-Additive Process(SAP)工法が挙げられる。SAP工法では、配線パターンを電気銅めっきで形成した後、無電解銅めっきやスパッタリング法によって形成された導電層(シード層)をエッチングして除去することで配線が完成する。銅厚の薄いシード層のエッチングはフラッシュエッチングと呼ばれ、フラッシュエッチング工程では、ターゲットであるシード層と同時にめっき配線もエッチングされ、配線幅が減少してしまう。このことから微細配線を形成するためには、シード層を優先的にエッチングし、配線に対してエッチング量が少ないプロセスを用いることが望ましい。
無電解銅めっきによって形成されたシード層は、膜厚が薄い上に、電気銅めっきによって形成された配線部分と比較してEtching Rate (E.R.)が高いためSAP工法によって形成される配線の幅は細りが少ないが、アンダーカットと呼ばれる水平方向の過剰腐食抑制(配線形状の矩形性)が従来から課題となっており、近年は加えて、高周波対応プリント配線板では配線表面の平滑化の要求が高まっている。高周波になると表皮効果により導体の表面状態が重要となり、高周波対応プリント配線板では配線表面の粗度が信号伝送速度に大きな影響を与えると言われていることから、アンダーカットおよび配線表面の低粗度化を両立したプロセスが求められている(図1)。
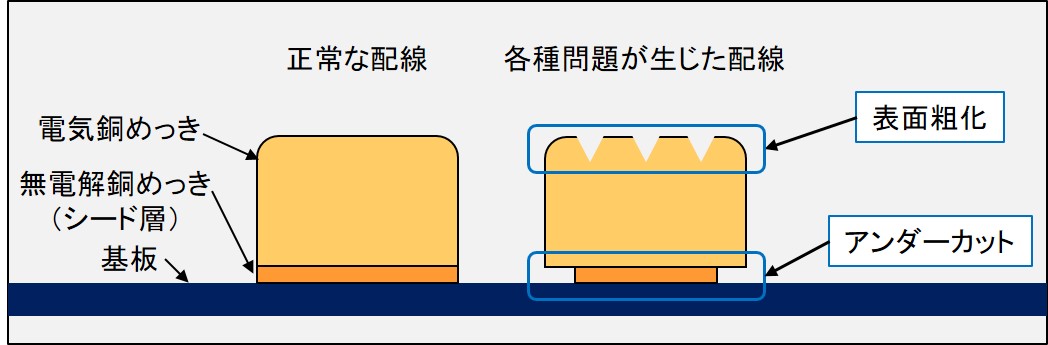
原理
SACⅡは、SAP工法基板における回路形成用の過酸化水素/硫酸系、銅フラッシュエッチングプロセスである。
SACシリーズは銅のエッチングを抑制することで、膜厚の薄い無電解銅めっきに対して、適正なエッチング量に制御することが可能である。銅のエッチングを抑制しながら、無電解銅めっきと電気銅めっきのE.R.差を保持するためSAP工法における微細配線形成の優位性は損なわれない。
SACⅡは配線表面にインヒビターを均一に吸着させる(図2)ことで、反応均一性を向上させているため、平滑な配線表面が得られるとともにアンダーカット抑制効果も有している。
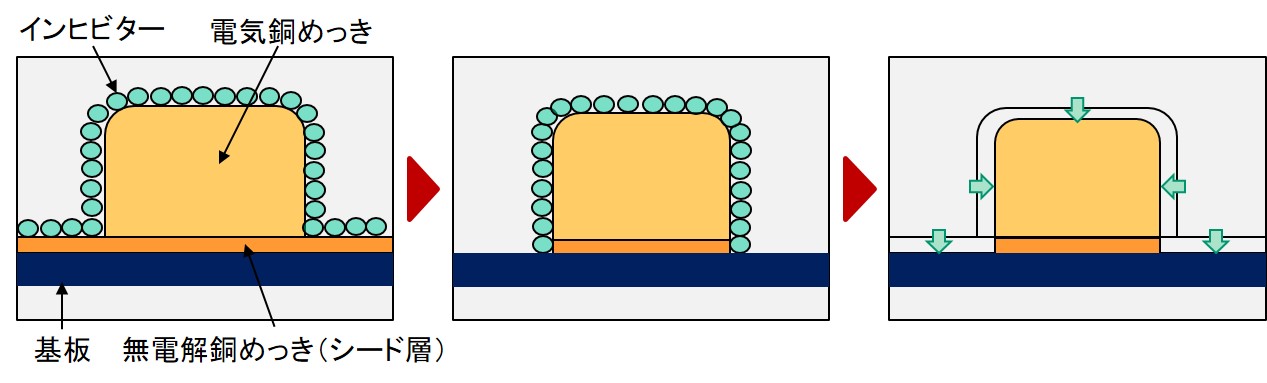
性能・特長
図3にSACⅡによって処理された配線の各種SEM像を示す。
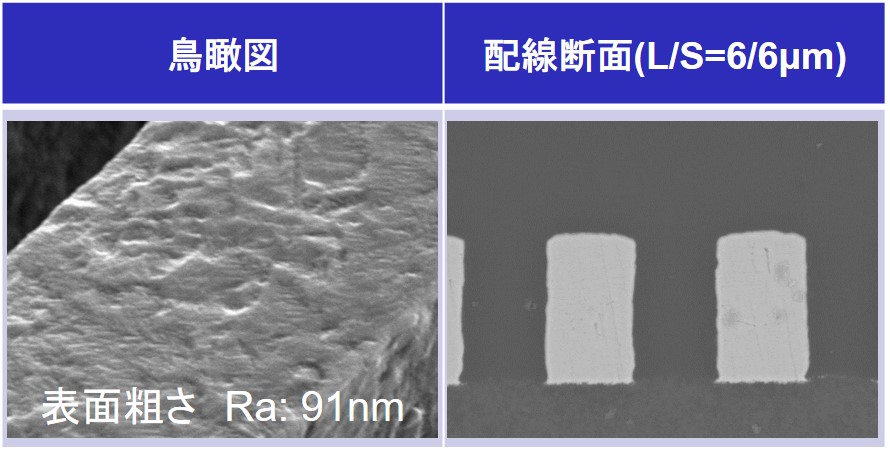
(協力会社:(株)オーク製作所)
図3示すようにSACⅡは低粗度処理が可能であるため、平滑な配線表面を維持しつつ、アンダーカットを抑制した良好な配線形状の矩形性を両立することが可能である。
おわりに
本プロセスの評価過程で得られた知見および課題を開発にフィードバックし、今後もプリント配線板の微細化・多様化に貢献していく所存である。




