TGV用硫酸銅めっきプロセス(開発中)
総合研究所 電子技術開発部 須賀 悠介 Yusuke SUGA 鈴木 翔太 Shota SUZUKI 相澤 涼 Ryo AIZAWA
長野 暢明 Nobuaki NAGANO 江田 哲朗 Tetsuro EDA
はじめに
近年、各所でInterposerや半導体パッケージ基板の開発が進められており、微細化、高機能化を目的として様々な材料、プロセスの検討が行われている。特に従来の有機基板には無い優秀な特性を持つ絶縁材料としてガラスが注目を集めており、これを用いたガラスInterposerの検討が加速している。
ガラスInterposerには貫通電極(Through Glass Via:以下、TGV)が設けられるが、この電極部分は電気銅めっきにより銅を充填することで形成される。しかしながら開口径が小さく、深さ方向が大きいため、従来の電気銅めっき技術ではこの貫通孔を完全に充填出来ないことが課題となっていた。
本稿では、上記課題に対応したガラスInterposer向けTGV用硫酸銅めっきプロセス(開発中)について紹介する。
ガラスInterposer
ガラスは誘電率が低く、高周波の電流に対しても誘電損失を抑える特長があるため、大容量かつ高速な通信の需要に対応することが出来る。
また、ガラスはSiウエハや有機基板と比較して剛性に優れているため反りが少なく、パッケージ基板サイズの拡大に対応することが出来る。さらに平滑性が高いため微細配線の形成にも適している。これらの多くの利点から、ガラスInterposerは次世代の半導体パッケージにおける重要な技術として検討が進んでいる。
ガラスをInterposerに適用する際、基板表裏の導通を得るためのTGVフィリングめっき技術が必要不可欠である。要求されるスペックとして基板の厚みが400μmt前後であり、開口径は60μm~100μmφである。図1にガラスInterposerとTGVの模式図を示す。
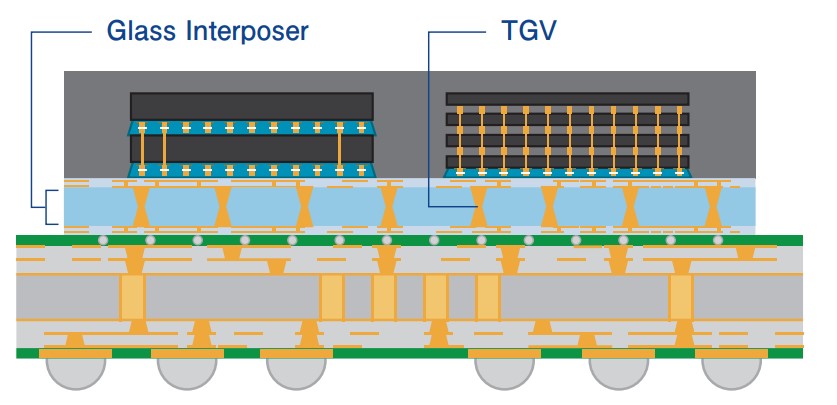
課題
ガラスInterposerに要求されるTGV基板は微細な開口径を有し、基板の厚みが厚いため高アスペクト比となる。このような高アスペクト比のスルーホールへの電気銅めっきでは、銅の充填(フィリング)が完全に行われず、ボイドと呼ばれる空隙が発生しやすい。ボイドの存在は接続信頼性の低下につながるため、ボイドなくフィリングを達成する必要がある。
特長
- TGVへの優れたフィリング性能
- ボイドの発生を抑制可能
フィリング性能
60μmφ-400μmtのTGV基板に対して、開発プロセスで電気銅めっきを実施した結果を図2に示す。図2の結果から、開発プロセスを使用した場合にはボイドが生じることなくフィリングを達成しており、高アスペクト比のTGV基板に対して優れた性能を有していることを確認した。
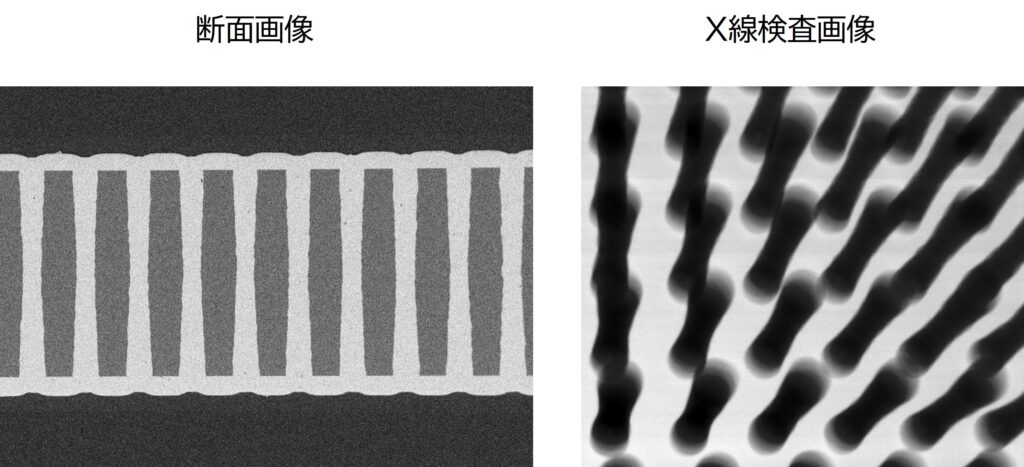
おわりに
本稿で紹介した当社開発中であるTGV用硫酸銅めっきプロセスは、高アスペクト比のTGV基板において優れたフィリング性能を有している。本プロセスは次世代の半導体実装技術への貢献が期待されるため、今後も開発を続けていく。




