SAP用硫酸銅めっきプロセス CU-BRITE VF8
総合研究所 電子技術開発部 安藤 俊介 Shunsuke ANDO 竹花 渉 Wataru TAKEHANA 岡田 将太郎 Shotaro OKADA
新規技術開発部 小林 歩 Ayumu KOBAYASHI
はじめに
AI技術の進歩やIoT化などデジタル化が急速に加速する中で電子機器の更なる高機能化やモバイル機器の小型化が進んでいる。プリント基板やパッケージ技術においても配線の微細化や部品密度の増加など、更なる進化が求められており、銅配線の形成や層間接続を行う電気銅めっきへの要求もより高度なものへと変化している。
Semi Additive Process(SAP)基板における電気銅めっきでは、配線の微細化やパッケージサイズの大型化に伴い、これまで以上の高い膜厚均一性が必要になっている。また、層間接続のためにブラインドビアホール(Blind Via Hole:以下、BVH)を銅で充填する必要もあるため、フィリング性との両立が求められているが、一般的に、フィリング性と膜厚均一性は相反することが知られている。今回、高い膜厚均一性とBVHフィリング性を両立可能なプロセスCU-BRITE VF8(以下、VF8)の開発を行ったので、紹介する。
SAP基板における膜厚均一性
SAPは絶縁層上にシード層形成後、非回路部にドライフィルムレジスト(以下、レジスト)などを形成し、露出したシード層部分のみを電気銅めっきで配線形成したのち、レジストの剥離、エッチングを行うことで、非回路部のシード層を除去し、回路形成を行う工法である。レジスト開口部をエッチングして回路形成するサブトラクティブプロセスと比較し、電気銅めっき後のエッチング量が少なく、微細配線の形成に有利な反面、電気銅めっき時に、めっき部と非めっき部が混在することで、めっき膜厚にばらつきが生じやすい傾向がある。めっき膜厚のばらつきはノイズの発生の要因となり、配線が微細化し、高周波となるほどノイズが大きくなるため、これまで以上にめっき膜厚のばらつきを抑制することが求められている。
めっき膜厚にばらつきが生じるのは、電流が集中する箇所や攪拌が強く銅イオンの供給量の多い箇所の膜厚が厚くなるためであり、前者は酸の濃度を上げ液の導電性を向上させることで、後者は攪拌の強い箇所のめっき析出を抑制する添加剤を用いることで改善が可能となる。しかし、硫酸濃度の上昇はBVHのフィリング性の低下を招くため、高い膜厚均一性とBVHフィリングの両立は困難であった。
そこで今回、高い膜厚均一性とBVHフィリング性を両立可能なプロセスであるVF8の開発を行った。
特長
- 高硫酸組成でのフィリング性と膜厚均一性の両立が可能
- 様々なBVHサイズに対応可能
- フラットな配線形状
- 幅広い電流密度に対応可能
- 長期にわたって性能を維持可能
性能
図1に従来プロセスとVF8のフィリング性能を、図2に膜厚均一性の比較を示す。
BVHスペックは65μmφ-40μmd、均一性評価では種々のスペックの配線部のめっき膜厚を測定した。めっき条件は電流密度:2A/dm²、目標膜厚:16μm、攪拌は噴流攪拌で行った。
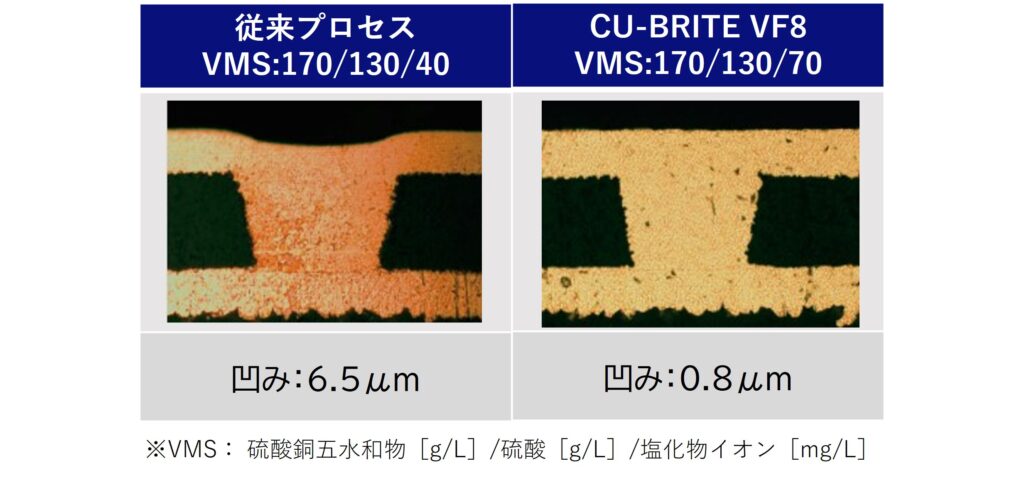
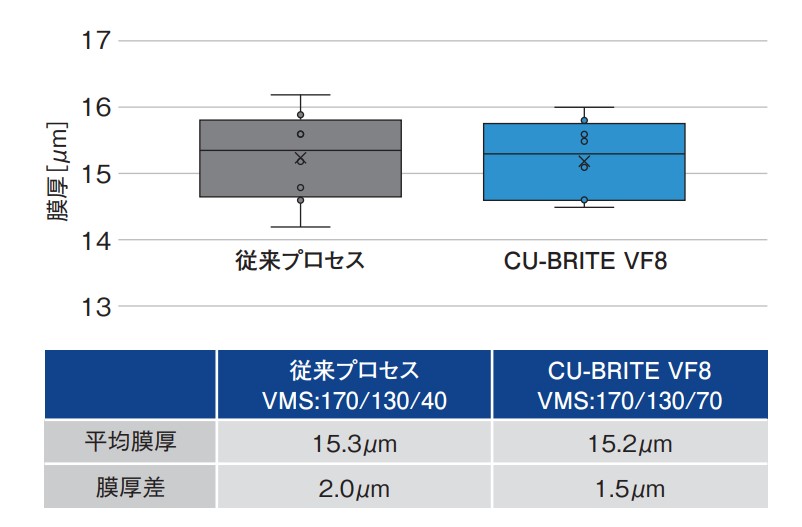
従来プロセスは膜厚均一性が良好である反面、高硫酸組成ではBVHの凹みが大きくなってしまう。VF8は高硫酸組成においても良好なフィリング性を発揮することが可能であり、従来困難であった高硫酸組成での膜厚均一性とBVHフィリング性の両立が可能なプロセスとなっている。
図3に電流密度2A/m²における種々のスペックBVHに対するフィリング性能を、図4には配線部のめっき形状を示す。
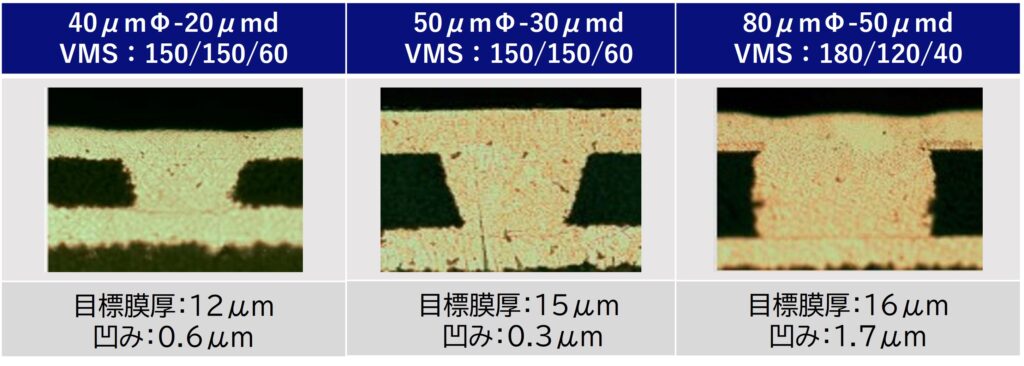

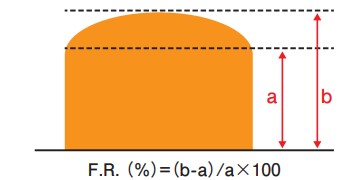
VMSや膜厚を調整することで、幅広いBVHサイズに対し、優れたフィリング性を発揮することが可能となっている。
また、電気銅めっき後の配線形状の平坦性(F.R.)にも優れており、実装や積層時に有利であると考えられる。
図5には高電流密度におけるフィリング性能を示す。BVHスペックは65μmφ-40μmd、目標膜厚は16μmで行った。
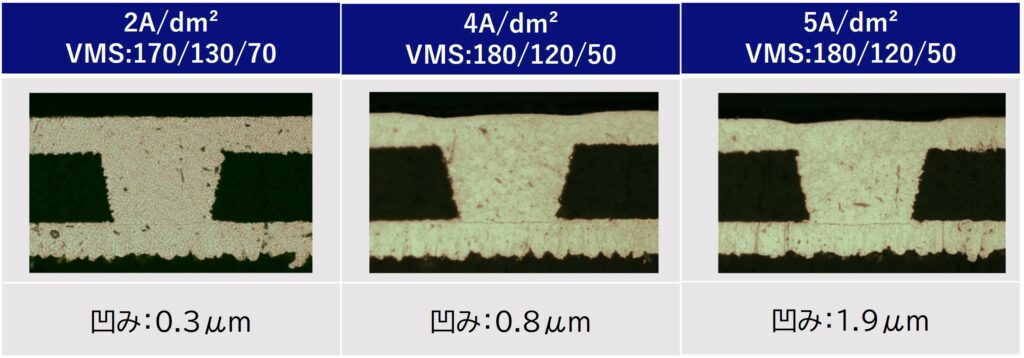
VMSを調整することで、高電流密度での性能低下を抑えることが可能であり、めっき時間の短縮による生産性向上が可能となっている。
図6に連続稼働時のフィリング性能、膜厚均一性の性能推移を、表1には銅めっき被膜の物性値を示す。


長期の電解後においても、フィリング性能、膜厚均一性の維持が可能であり、長期に渡って安定的に使用することができる。また、従来プロセス同様めっき被膜の物性値も良好である。
おわりに
CU-BRITE VF8は高硫酸組成におけるフィリング性能に優れ、これまで困難とされてきたフィリング性能と膜厚均一性の両立が可能なプロセスとなっており、幅広いスペック、めっき条件に適応可能である。
今後も高まる市場要求に応えるべく、開発を続けていく。




