高面均性スルーホールフィリングプロセス(開発中) CU-BRITE TF7
総合研究所 電子技術開発部 江田 哲朗 Tetsuro EDA 中川 翔太 Shota NAKAGAWA 白井 友貴 Yuki SHIRAI
解析技術部 岸本 一喜 Kazuki KISHIMOTO 技術情報部 佐藤 洋一 Yoichi SATO
はじめに
約10年周期で世代交代となる移動通信システムは第5世代(以下5G)に至り、内閣府が提唱するSociety5.0に代表される人工知能(AI)と5Gの相互作用による新たな社会システムの到来により、我々の生活が一変しようとしている。5Gの通信特性およびそれに基づくコンテンツ・サービスが与える社会的影響度の大きさから、この社会システムを支えるモノのインターネット(IoT)に関するデバイスに要求される信頼性の規格と、その担保に要する技術的課題は、今までよりもはるかに厳しくなる。
開発背景と課題
高周波対応基板において、解決されるべき課題としてノイズの問題がある。配線は微細化するにつれ、その導体抵抗が高くなり、実装においても接続部とのインピーダンスの不整合性が信号の反射となりノイズが発生する。ミリ波等の高周波ほどノイズが発生しやすく、具体的には配線(導体)の幅、厚み、表面粗度、接続性と、絶縁層の比誘電率等の要素すべてに起因される。つまりCuめっきでの配線形成においてめっき膜厚が不均一であると、高周波を送受信する5Gデバイスは、意図しないノイズを周囲に拡散させ、また逆に自身が外来ノイズを受信してしまうことで誤作動を起こすなどの不具合が発生する恐れがある。
上記の課題に対し、当社はCuめっきプロセスとしてフィリング性とパターン面内均一性とを両立した、高精度回路形成プロセスCU-BRITE TF7を提案する。
特長
- 優れたフィリング性とパターン面内均一性を両立
- 配線矩形性に優れる
- 様々なBVH/X-Viaへ適用可能
- 長期稼働においても優れたプロセス安定性を維持
フィリング性とパターン面内均一性の両立
これまでフィリング性とパターン面内均一性は相反する関係にあったが、鋭意検討の結果、CU-BRITE TF7では両立が可能となった。130μmφ‐100μmdの大径ビアに対しても良好なフィリング性を示すと同時に、配線の丸み率を示すFlat Ratio(以下、F.R.)は20%以下の優れた矩形性を有し、Embedded Trace Substrate(以下、ETS)におけるUnitのめっき膜厚偏差を大幅に改善することに成功した。(図1~図4)
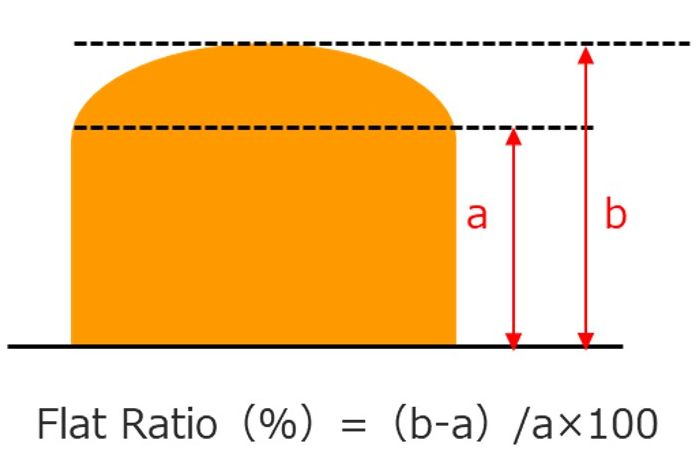
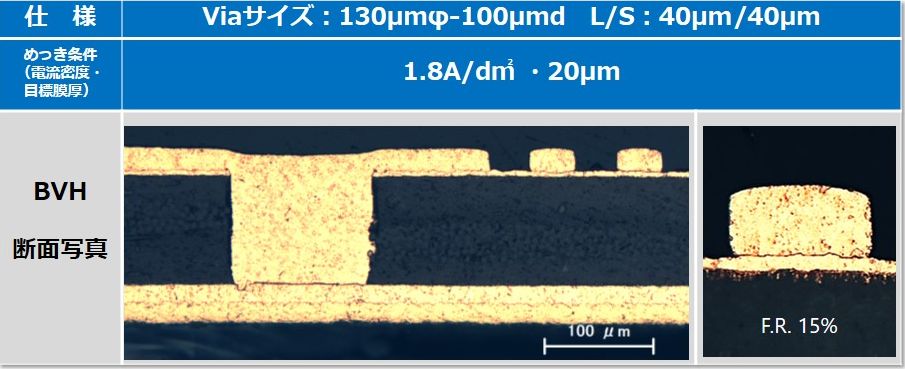

上)従来プロセス 下)CU-BRITE TF7

目標めっき膜厚: 20μm
上記のようにCU-BRITE TF7は微細配線部の膜厚が低下することなく、優れたパターン面内均一性、配線矩形性およびフィリング性に優れることが最大の特長である。
BVH/Bar Via/X-Viaフィリング性
BVHやX-Viaへのフィリング性に求められる課題の一つは、基板スペックを限定しない適応力である。有底Viaと貫通X-Viaのフィリング能力は必ずしも比例せず、加えて上述した面内均一性をも兼ねる性能は長年改善されるべき課題であった。これらのスペックすべてを工程管理の観点から一元管理できれば、多大なメリットとなる。図5~図7に、CU-BRITE TF7プロセスを使用した各種スペックへの対応例を示す。
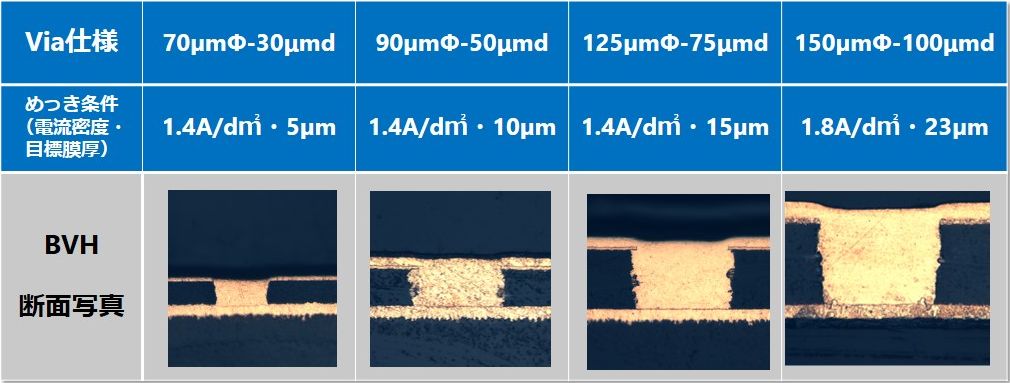
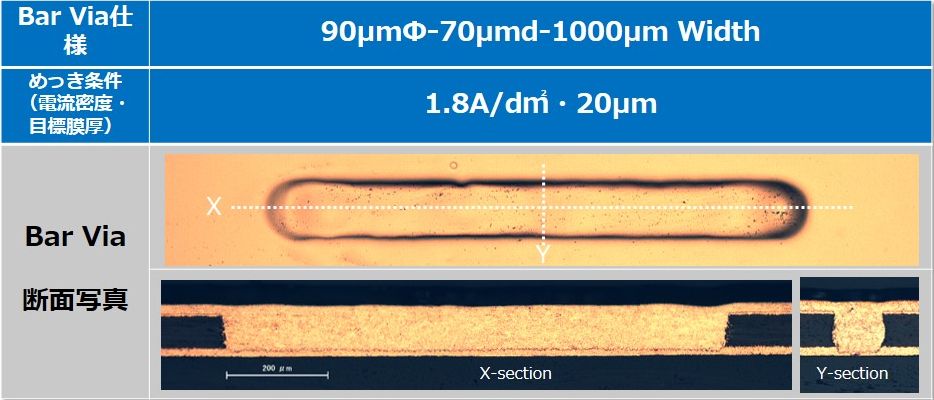
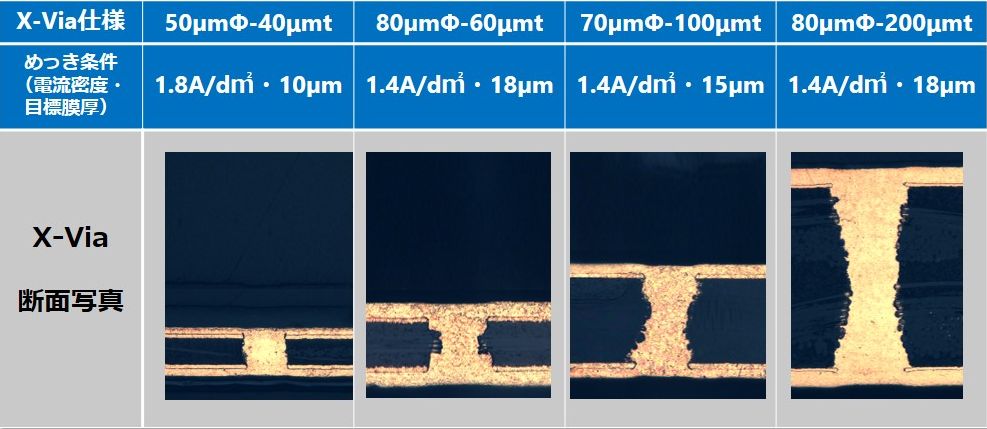
CU-BRITE TF7は、放熱性を重視した充填体積が非常に大きいBar Viaへの適用も可能なフィリング性を有している。かつ、各種スペックに対してフィリング形状が凸形状(オーバーフィル)となりにくく、配線の矩形性と合わせてビルドアップおよび実装性にも有利であることも特長である。
長期稼働における性能安定性
連続稼働時の各性能値の推移を図8~図10に示す。
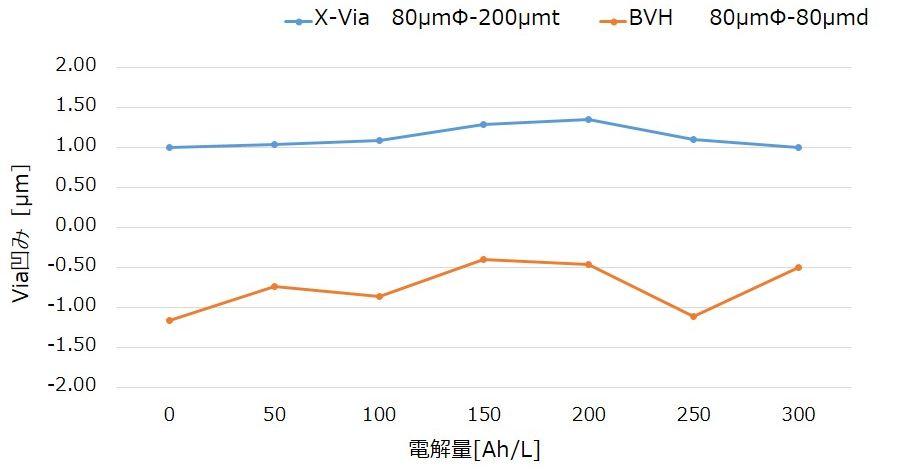


長期稼働においても優れたフィリング性と面内均一性を維持することを確認した。
被膜物性

従来プロセスと変わらない優れた被膜物性値を有する。
使用条件

特別な仕様を要求せず従来プロセスと同等の管理項目が適用可能。
おわりに
高面均性スルーホールフィリングプロセスCU-BRITE TF7は、フィリング性とパターン面内均一性を兼ね備える点で従来プロセスにない特長を有しており、高精度な配線形成性が要求されるFC‐CSP, FC‐BGA基板への適用が可能である。
今後も5Gはもとより、Beyond 5G , 6Gの市場要求に対応する製品開発を続けていく。




