選択的ニッケルエッチングプロセス(開発中) EBASTRIP ST-NI2
総合研究所 電子技術開発部 泉谷 美代子 Miyoko IZUMITANI 長野 暢明 Nobuaki NAGANO
はじめに
近年、5Gの普及に伴い半導体パッケージ基板は一段と高密度化しており、Cu配線の微細化も進んでいる。半導体パッケージ基板は一般的にセミアディティブ工法で形成されるが、シード層エッチングの際にCu配線に与える影響をいかに少なくするかが重要な課題となっている。この課題の解決にはさまざまなアプローチがあり、シード層をNiなどCu以外の金属で形成し、選択的にCu以外の金属をエッチングするという手法も検討されている(図1)。このような需要に対し、以前当社ではCuを保護し、Niシード層を選択的にエッチングできるEBASTRIP ST-NIプロセス(以下従来プロセス)を開発した。しかし、従来プロセスは連続稼働での安定性が極めて高い一方、Pを多く含有するNiシード層に対してはエッチングが難しいという課題があった。
本稿では、P含有率が高いNiシード層でもエッチングが可能である開発品EBASTRIP ST-NI2プロセス(以下ST-NI2)について紹介する。
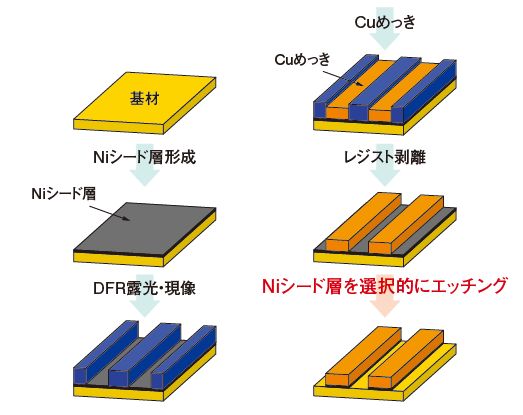
上記課題を踏まえ、当社ではアンダーカットを抑制しCu配線表面の平滑性を維持できるSAP用エッチングプロセスFINEETCH SAC3(以下SAC3)を開発している。本稿ではその性能について報告する。
製品性能の比較
従来プロセスとST-NI2の性能比較を表1に示す。また、ST-NI2の主な特長を以下に挙げる。
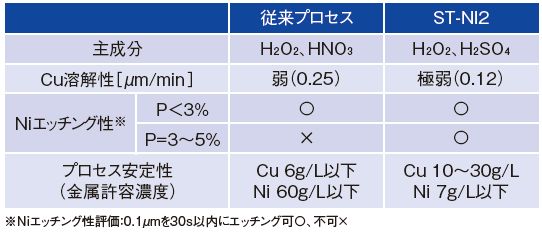
特長
①P含有率が3~5%のNiシード層でもエッチング可能
無電解Niめっき(P含有率3~5%)後の基板を各プロセスで処理した際の基板表面をSEM-EDSで分析した結果を図2に示す。従来プロセスで処理した基板はNiのピークが検出されたが、ST-NI2で処理した基板はNiのピークが検出されず、Niが完全にエッチングされたことが確認された。

②Cuめっき表面の形状変化が小さい
電解Cuめっき基板をST-NI2で処理したときの表面形状を図3に示す。処理前後でのCuめっき表面の形状変化はほとんどみられず、Cuめっき表面への影響が小さいことが確認された。
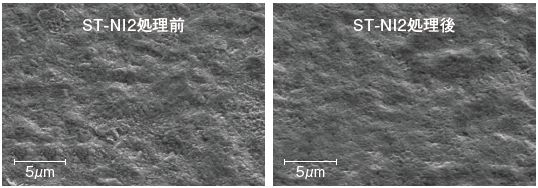
おわりに
今回紹介したEBASTRIP ST-NI2は、従来プロセスよりもCuの溶解性を抑制し、P含有率の高いNiシード層でも選択的にエッチングが可能なプロセスである。さまざまな分野で、プロセスの特長を生かせる市場に展開していきたい。




