低アスペクト比スルーホールフィリング対応めっきプロセス CU-BRITE TFL
CS技術統括部 電子技術部 曽根 絵理子 Eriko SONE 佐波 正浩 Masahiro SAWA
総合研究所 解析技術部 谷本 由実 Yumi TANIMOTO
はじめに
スマートフォンをはじめとした電子機器は軽薄短小化が重視されており、内部に搭載されるプリント基板にも薄型化が要求されている。プリント基板のコア層では、層間接続のためにコンフォーマルめっき後に導電性ペーストでスルーホールを充填する工法が主流であったが、プリント基板の高機能化に伴い、より接続信頼性や放熱性に優れるスルーホールフィリングめっきの採用が増加している。
このコア層のスルーホールにおいても低背化の要求を受け、樹脂厚は薄いものが増加しているが、スルーホールの開口径は接続信頼性の観点から従来と大きく変化していない。そのため、低アスペクト比(樹脂厚を開口径で割った値が小さい)のスルーホールが増加している。
本稿では、このような低アスペクト比のスルーホールに対して薄膜でフィリング可能なプロセスCU-BRITE TFL(以下TFL)について紹介する。
低アスペクト比スルーホールフィリング
一般的に、スルーホールフィリングめっきでは、Cuイオンの供給されやすいプリント基板表面のCuの析出を抑制し、スルーホール内部を優先的に析出させることでフィリングを可能としている。樹脂厚の薄いスルーホールでは、基板表面とスルーホール内部でCuイオン供給量に差がつきにくい、すなわち、表面とスルーホール内部における抑制効果の差が小さいため、従来のスルーホールフィリングめっきプロセスでは、スルーホール内部の優先析出性に乏しく、十分なフィリング性能を確保するためにめっき表面膜厚を厚くつける必要があった。
めっき表面膜厚の薄膜化
プリント基板の低背化、微細化や高密度化といった要求に応えるために、Cuめっき表面膜厚の薄膜化が必要である。TFLは、表面とスルーホール内部での抑制力の差を大きくすることで、低アスペクト比のスルーホールに対して薄膜でのフィリングが可能となった。また、その優れたフィリング性能により、ブラインドビアホール(以下、BVH)やBar Viaと呼ばれる楕円形や長方形のBVHに対しても、薄膜でのフィリングが可能である。
TFLの特長
- 低アスペクト比スルーホールの薄膜フィリング
- BVH/Bar Viaへの優れたフィリング性能
- 連続稼働でも安定した性能を維持
スルーホールフィリング性能
図1、2に従来プロセスとTFLとの低アスペクト比スルーホールへのめっき性能比較を示す。従来プロセスではスルーホールを完全にフィリングするには18μmのめっき表面膜厚が必要だが、TFLプロセスでは12μmで充分なフィリングが可能となっている。
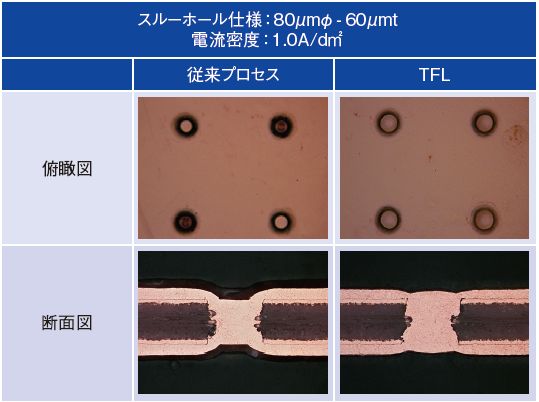
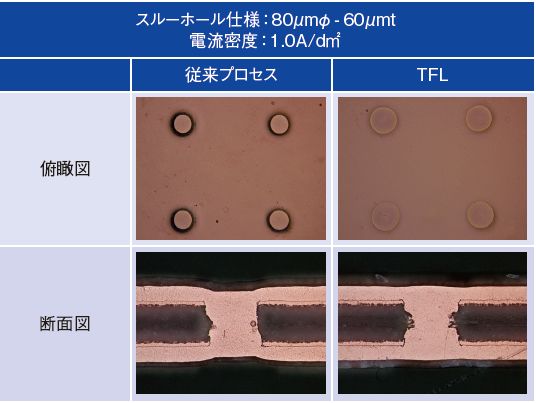
CVSでのメカニズム解析
Cyclic Voltammetry Stripping(CVS)は主にめっき薬液中の添加剤濃度を分析するために用いられる方法で、電極の電位を周期的に走査することにより、相対的なめっきの析出量を測定することができる。電極は回転数の調整が可能で、回転数によりめっき析出表面での攪拌の強弱を再現できる。
CVSを使用して、攪拌の強弱によるめっき析出量の変化を調査した結果を図3に示す。結果から、TFLは、従来プロセスと比較して攪拌が弱い部分での析出量の増加率が高いことが確認された。スルーホールにおいては、表層に当たる攪拌がもっとも強く、穴内部になるほど攪拌は弱くなっていると考えられる。結果から、攪拌の弱い部分において、TFLは従来プロセスよりも析出量の増加率が約2倍になることが確認された。これが薄膜フィリングを可能にする一因と考えられる(図4)。
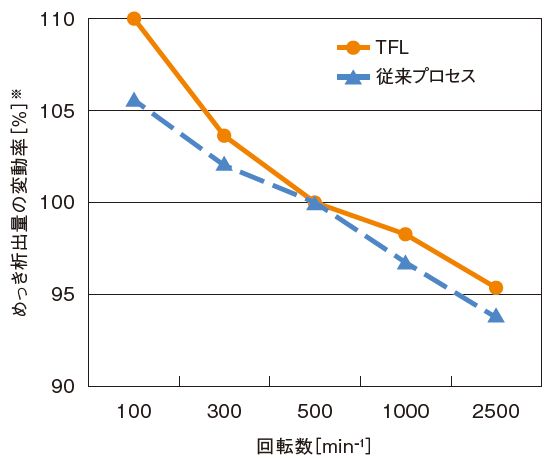
※めっき析出量は電極の回転数500min-¹での値を100%として換算
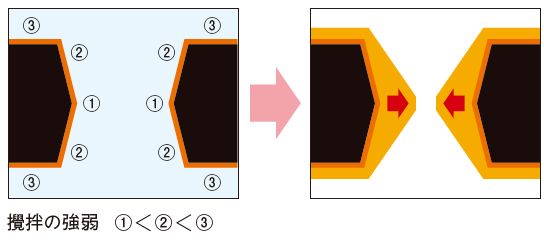
BVH/ Bar Viaへの適用
TFLは、低アスペクト比スルーホールだけでなくBVHに対しても優れたフィリング性能を有している。図5、6にBVHとBar Viaへのフィリング性能をそれぞれ示す。
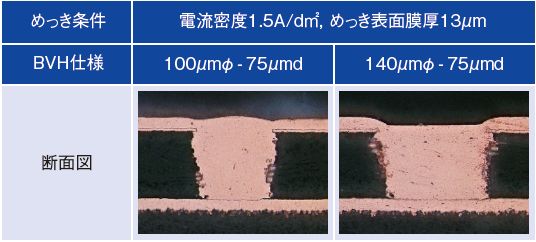
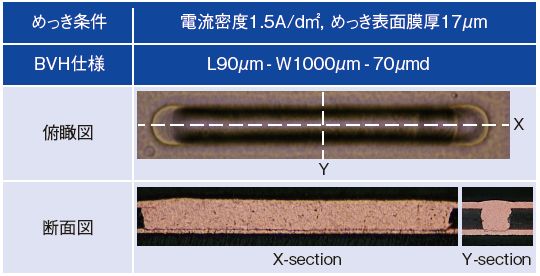
TFLは、体積が大きくフィリングが難しいBar Viaに対しても優れたフィリング性能を有している。
連続稼働における性能安定性
TFLの連続稼働時におけるスルーホールフィリング性能の評価結果を図7に示す。評価試験で使用した基板のスルーホールサイズは80μmφ-60μmt、評価試験時の電流密度は1.0A/d㎡、めっき表面膜厚は13μmである。スルーホールフィリング性能は、めっき後の表面とスルーホールの段差(凹み量)で評価した。

電解量300Ah/Lでもスルーホールの凹み量は安定しており、TFLは連続稼働でもフィリング性能を維持できることを確認した。
おわりに
CU-BRITE TFLは、従来プロセスでは困難であった低アスペクト比のスルーホールの薄膜フィリングを可能とし、体積の大きいBVHに対しても優れたフィリング性能を有している。
めっき表面膜厚の薄膜化は、工数削減や時間短縮による生産能力の向上、金属使用量や電気使用量の削減効果も期待される。TFLは、環境負荷低減にも貢献できるプロセスであると考えている。




