低アスペクト比スルーホールフィリング対応めっきプロセス CU-BRITE VLX
総合研究所 新規技術開発部 谷本由実 Yumi TANIMOTO
電子技術開発部 安藤俊介 Shunsuke ANDO
はじめに
近年、スマートフォンをはじめとする電子機器の発展に伴い、プリント配線板の微細化、高密度化、高機能化が進んでいる。それに伴い、硫酸銅めっきに対する要求も多様化しており、当社はこれまでその要求に対応すべく様々なプロセスを開発してきた。
今回、低アスペクト比スルーホール(以下、TH)フィリング対応めっきプロセスとしてCU-BRITE VLXを開発したので紹介する。
THフィリング
従来、ビルドアップ配線板のコア層では、THにTHめっきを行い、導電性ペーストを充填した後に積層を行っていた。しかし、THめっきをTHフィリングめっきに変更することで、導電性ペーストによる充填が不要となり、下記のような利点が得られる。
- 工程短縮
- 接続信頼性の向上
- 放熱性の向上
THフィリングめっきはこれらの利点によってプリント配線板の高機能化を可能にするため、ビルドアップ配線板において使用量が増加傾向となっている。
図1にそれぞれの工法で処理されたビルドアップ配線板コア層のモデル図を示す。
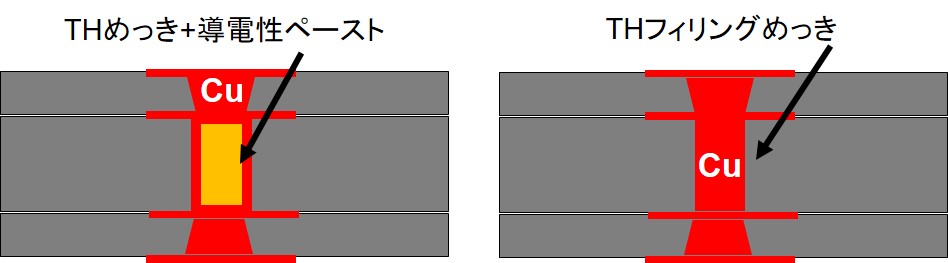
また近年、穴径が広く、樹脂の厚さが薄い低アスペクト比THをコア層に採用したプリント配線板のデザインが増加している。
このような低アスペクト比THを従来のプロセスでフィリングを行う場合には、以下のような問題がある。
- めっき膜厚の厚膜化
- ブラインドビアホール(以下、BVH)フィリングとの両立が困難
CU-BRITE VLXはこれらの問題を解決し、同一組成で低アスペクト比THとBVHフィリングを行うことが可能で、更にフィリングに必要な膜厚を低減したプロセスとなっている。
性能
図2にBVHおよびTHの断面写真を示す。対象配線板に従来プロセスおよびCU-BRITE VLXを用い、電流密度は2A/dm2で処理を行った。
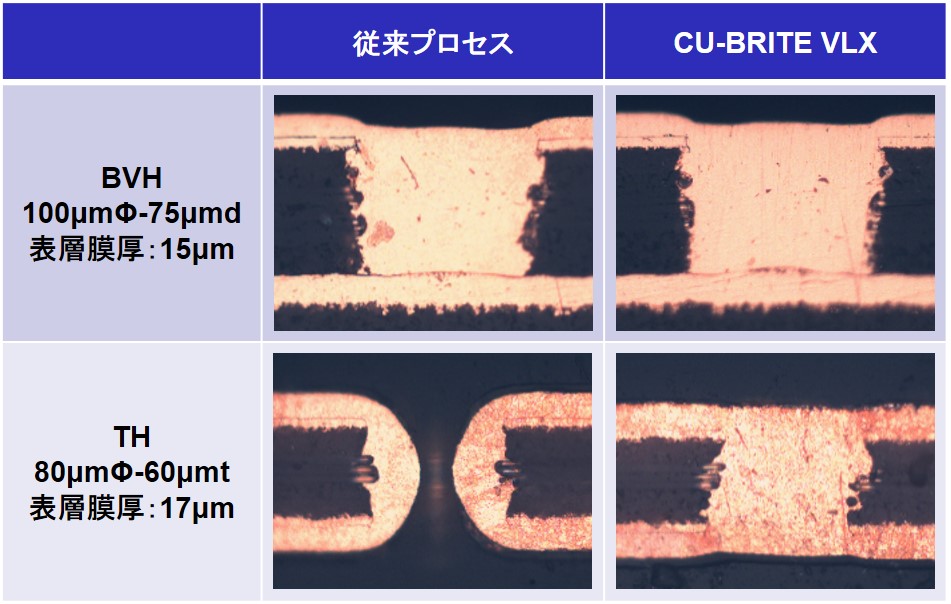
従来プロセスでは、BVHに対するフィリング性は良好だが、低アスペクト比THでのフィリング性が充分ではない。
CU-BRITE VLXは従来プロセスでは困難であったBVHと低アスペクト比THのフィリングが両立可能となっている。
図3に種々の配線板に対するCU-BRITE VLXのフィリング性能および配線断面を示す。
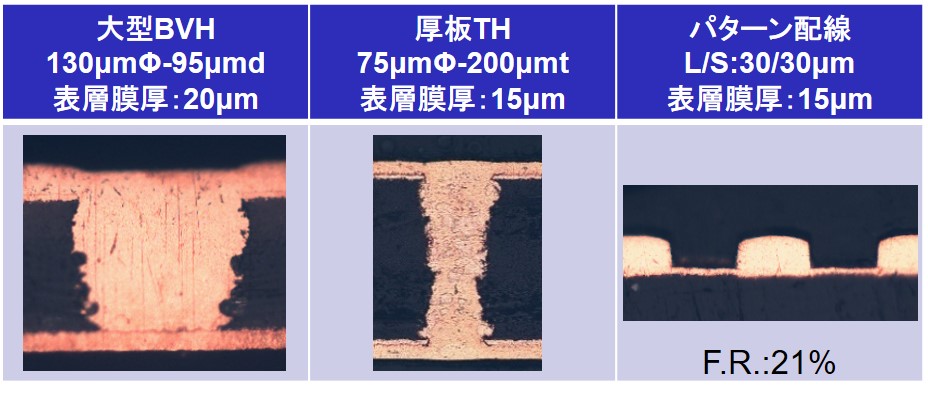
CU-BRITE VLXは多様な配線板に対応可能である。
おわりに
CU-BRITE VLXは従来プロセスでは対応できなかった低アスペクト比THのフィリング性に優れ、また幅広い配線板への対応が可能なプロセスである。これらの高い性能により、今後も更に多様化、高度化する硫酸銅めっきへの要望に応えることが可能であると確信している。




