ハイスローイングパワーめっきプロセス CU-BRITE 51
総合研究所 電子技術開発部 福田耀大 Kouta FUKUDA 小林玲斗 Reito KOBAYASHI 江田哲朗 Tetsuro EDA
新規技術開発部 岸本一喜 Kazuki KISHIMOTO
はじめに
電子機器の高機能化に伴い、プリント配線板の高密度化、すなわち多層化やスルーホール(以下、TH)の小径化が進んでいる。そのため、高アスペクト比のTHへ対応できるめっき技術が求められている。そこで本稿では、高アスペクト比THを対象とする銅めっきプロセスとして新規に開発したCU-BRITE 51について報告する。
開発背景・コンセプト
近年、高アスペクト比THめっきにおいて均一電着性(以下、T.P.)の要求がますます高くなっている。当社の従来プロセスは多くの性能では高い評価を得ているものの、T.P.については市場要求を満たせないケースが発生しつつある。そこで今回、従来プロセスで好評な諸性能を損なうことなく、T.P.を向上させたプロセスとしてCU-BRITE 51の開発を行った。
特長
- 高アスペクト比THへの高いT.P.
- 高い浴安定性
- ブラインドビアホール(以下、BVH)への優れた付きまわり性
THめっき性能
図1にCU-BRITE 51のTHめっき性能を示す。従来プロセスと比較するとT.P.が平均5%向上しており、THコーナー部の凹みなども発生していない。
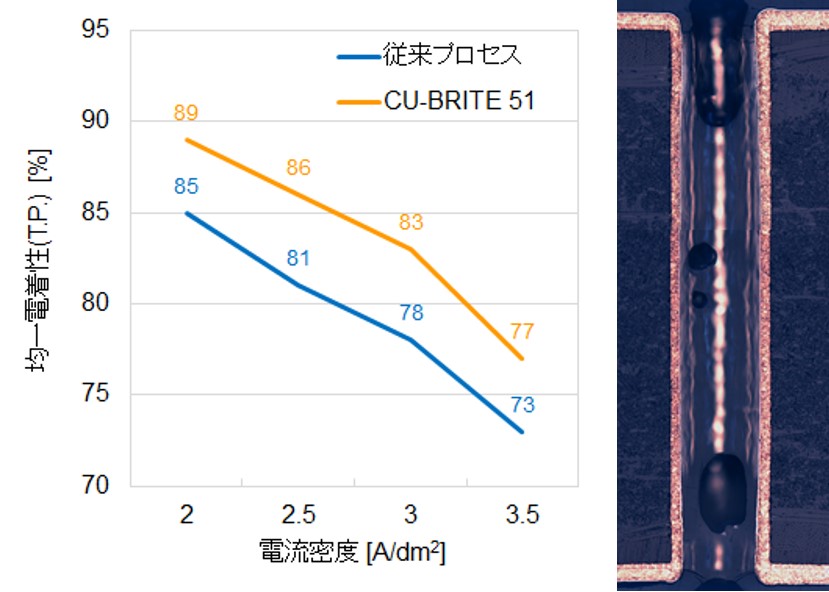
図1 CU-BRITE 51めっき性能(TH)
また、薬液電解量が1,500 AH/Lを超えても性能を維持しており、安定性が高い事を確認している。(図2)

図2 薬液電解量とT.P.の関係性
BVHめっき性能
図3にCU-BRITE 51でめっきしたBVHの断面写真を示す。T.P.は95%と高く、従来プロセスと同等の良好な付きまわり性を有している。
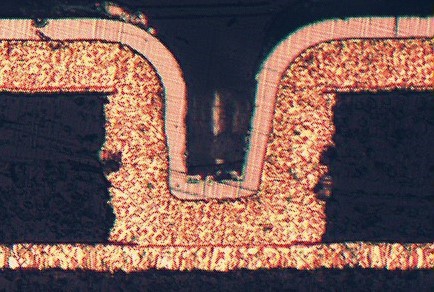
図3 CU-BRITE 51断面写真(BVH)
皮膜物性
表1に皮膜物性のデータを示す。いずれも従来プロセスと同等であり、また連続稼働による性能低下は認められなかった。

おわりに
今回紹介したCU-BRITE 51は、従来プロセスからT.P.を約5~10%向上させた製品である。また、BVH付きまわり性や安定性などの諸性能も従来プロセスと比較して遜色なく、高いパフォーマンスを発揮できる。
今後とも市場からの要求に応える高品質かつ高性能な製品開発を進めていく。




