SAP用回路形成エッチングプロセス(開発中) FINE ETCH SAC3
総合研究所 電子技術開発部 文蔵 隆志 Takashi FUMIKURA
はじめに
電子機器に搭載される半導体の高性能化に伴い、半導体パッケージ基板はCu配線の微細化、高密度化が進んでいる。
また、5Gなどで使用される高周波帯での高速データ通信では、電気信号はCu配線表面の粗さによる伝送損失を受けやすくなるため、Cu配線表面はより平滑であることが要求される。
半導体パッケージ基板の製造には、微細なCu配線形成が必要となることから一般的にSemi-Additive Process(SAP)が多く用いられている。SAPのCuシード層エッチングにおいては、局所的な過剰腐食であるアンダーカット(図1)の防止やCu配線表面の平滑性を維持することが課題である。
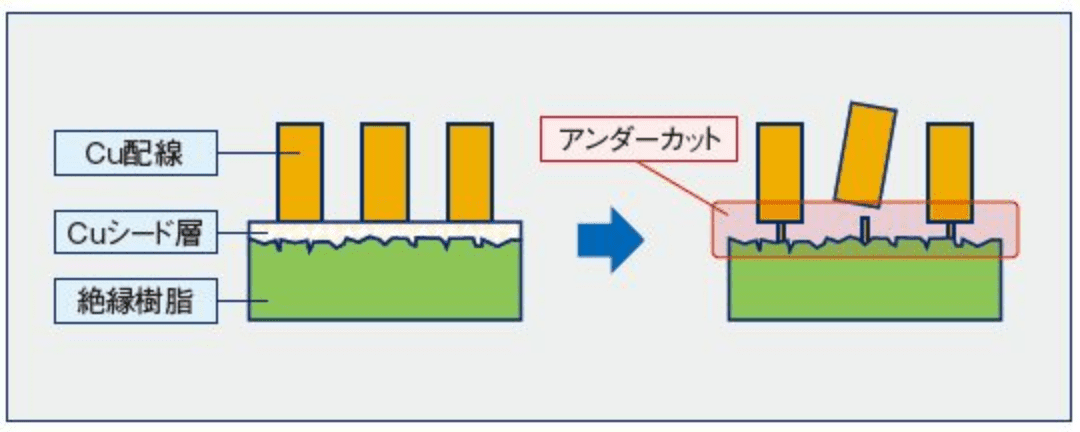
上記課題を踏まえ、当社ではアンダーカットを抑制しCu配線表面の平滑性を維持できるSAP用エッチングプロセスFINEETCH SAC3(以下SAC3)を開発している。本稿ではその性能について報告する。
特長
SAC3は、過酸化水素/硫酸系のエッチングプロセスであり、以下に示す特長を有する。
- アンダーカットの抑制
- Cu配線表面の平滑性維持
- 連続稼働時の性能安定性
性能
アンダーカットの抑制
SAC3は高いアンダーカット抑制性能を有する。SAP基板のL/S=10/10μm箇所を、一般的な過酸化水素/硫酸系ソフトエッチングプロセス(以下従来プロセス)とSAC3でエッチングした断面比較を図2に示す。従来プロセスを用いてエッチング処理を施した基板では、Cuシード層とCu配線との界面にアンダーカットが生じている。一方SAC3を用いた場合では、アンダーカットの発生はみられない。
また、さらに微細なCu配線であるL/S=5/5μmの基板で同様に確認した結果を図3に示す。従来プロセスではアンダーカットが起因して一部にCu配線の剥離が確認されたが、SAC3ではアンダーカットやCu配線の剥離は発生していない。
さらに、SAC3でエッチング量を増加させた条件のCu配線断面を図4に示す。Cuシード層が残渣なくエッチングされた条件をJust Etchとし、その条件の2倍および3倍にエッチング量を増加させた条件を過剰エッチング条件とした。過剰にエッチングした場合、Cu配線幅の縮小はみられるが、いずれの条件においてもアンダーカットおよびそれに伴うCu配線の剥離は発生していない。
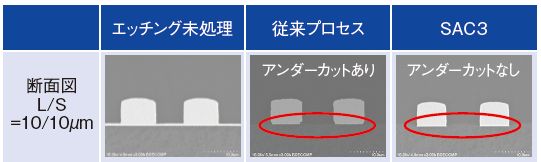
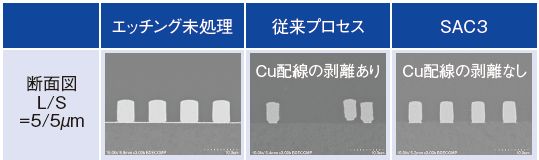
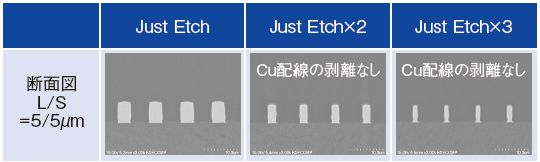
Cu配線表面の平滑性維持
SAC3はエッチング後のCu配線表面の平滑性を維持できる。前項同様、SAP基板L/S=10/10μm、L/S=5/5μm箇所を従来プロセスとSAC3でエッチングしたCu配線の表面状態の比較を図5、図6に示す。従来プロセスで処理した場合、エッチング未処理の状態と比較し、Cu配線表面が粗化され、平滑性が無くなっている。一方SAC3を用いた場合では、Cu配線の表面はエッチング未処理の状態と比較してもほぼ変化がないことがわかる。
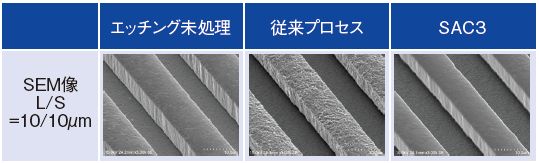

図7にエッチング量を増加させた条件のCu配線表面写真、図8に表面粗さの標準偏差(以下Rq)の増加量を示す。SAC3を用いた場合、Rqの増加量は従来プロセスと比較して大幅に低減されている。過剰にエッチング処理を行った場合でも、エッチング量に応じたRqの増加はみられるものの、従来プロセスと比較してその増加量は抑えられている。
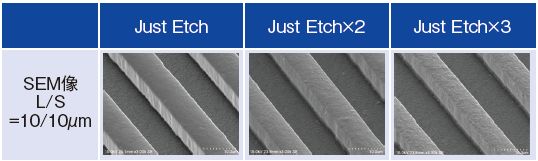
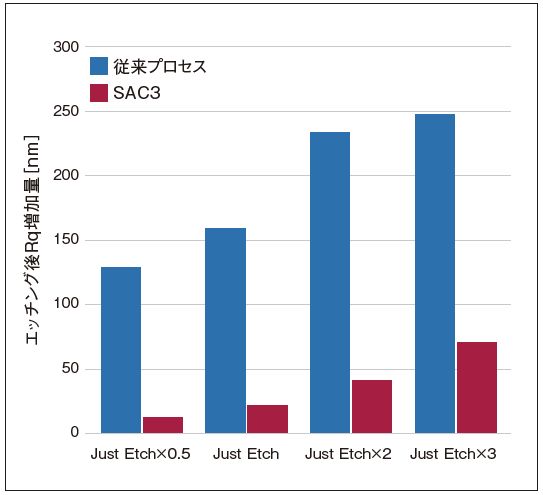
連続稼働時の性能安定性
SAC3は、Cu溶解量に対し定量的な補給を実施することで、安定した性能を維持することが可能である。図9にSAC3の新規建浴液と連続稼働液で処理したCu配線の断面および表面写真を示す。SAP基板を3㎡b/L連続稼働し新規建浴液と性能を比較したところ、アンダーカット、表面粗さとも大きな変動はなく安定したエッチング処理が可能であることが確認された。
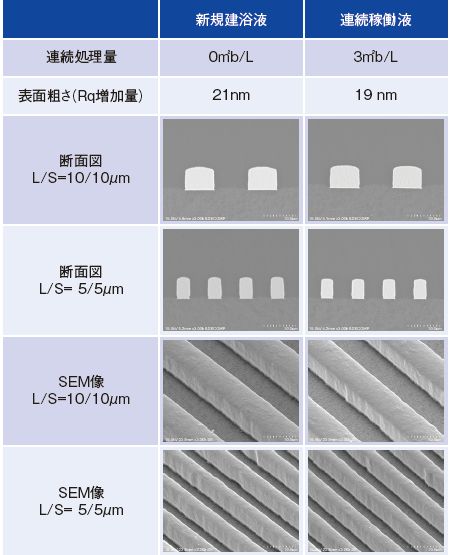
おわりに
FINE ETCH SAC3は、これまでSAPのCuシード層エッチング処理で課題であったアンダーカットの抑制とCu配線表面の平滑性の維持が可能なプロセスである。微細なCu配線の形成に加え、5Gなど高周波帯での伝送損失の低減にも期待できるエッチングプロセスとなっている。




