SAP用回路形成エッチングプロセス NEZARK®SAC9
総合研究所 電子技術開発部 泉谷 美代子 Miyoko IZUMITANI 三田 柾斗 Masato MITA 松山 哲大 Tetsuhiro MATSUYAMA
はじめに
オンラインでの映像通信や大規模データを学習する生成AIなどが普及し、私たちの暮らしはますます便利な世の中へと進化を遂げている。これらの生活基盤を安定的に支えるためには、半導体や各種デバイスを搭載した電子機器にはリアルタイムで大量のデータを高速処理する性能が必要である。近年では、このようなニーズに応えるため、半導体の技術進歩のみならず、新たな集積化技術を用いることで高性能化を目指す動きがある。特に半導体パッケージ基板では、Cu配線の微細化に加え、集積化技術の進展に伴う基板の大型化が進んでいる。
微細なCu配線の形成には、セミアディティブプロセス(Semi-Additive Process:以下、SAP)が広く用いられる。図1に示すように、SAPにおけるシード層エッチングとしては、微細化に伴う課題として、局所的な過剰腐食であるアンダーカットや過度な配線幅の減少が挙げられる。また、伝送損失に関わる課題としてエッチング後の表面粗さの増加が挙げられる。
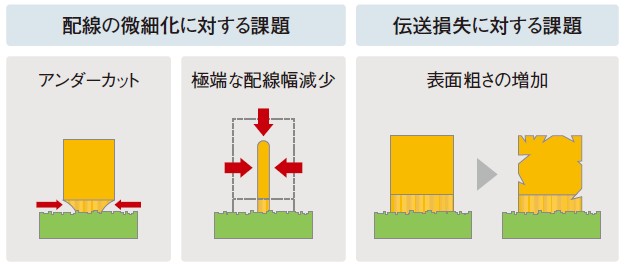
シード層エッチングにおいて、アンダーカットや過度な配線幅の減少が生じると、信頼性や歩留まりの低下につながる。また、高速伝送で用いられる5G/6Gなどの高周波帯では、表皮効果により電流が配線の表面近傍に集中するため、配線の表面粗さの増加は伝送損失を増大させる。これらの課題に対応するには、配線幅の縮小およびアンダーカットを抑制し、表面粗さの増加を抑制できるシード層エッチングプロセスが望ましい。
このような背景から、当社では、配線幅減少量の抑制およびアンダーカットの低減に加え、配線表面の粗さを抑制し、平滑性に配慮したシード層エッチングプロセスNEZARK® SAC9(以下、SAC9)を開発した。本稿では、その特長と各種性能(エッチング加工性能、連続稼働時の安定性、スパッタシード層への適用)について紹介する。
特長
SAC9は、過酸化水素/硫酸系のエッチングプロセスであり、以下に示す特長を有する。
- 配線幅減少量の抑制
- アンダーカットの抑制
- 表面粗さ増加の抑制
性能
■エッチング加工性能
SAP基板(無電解Cuめっきシード層厚み0.3μm)に対し、従来プロセス(過酸化水素/硫酸系エッチング)とSAC9を用いて処理した際のエッチング断面および配線の表面観察結果を図2に示す。
SAC9は従来プロセス同様にアンダーカットの抑制効果や表面粗さの増加抑制効果があるため、アンダーカットは生じておらず、表面粗さの変化も僅かとなっている。一方で、SAC9の配線幅減少量は従来プロセスと比較しても小さいことや、配線の上部においても線幅を保持していることから、矩形性の高い配線が形成されていることが確認できる。
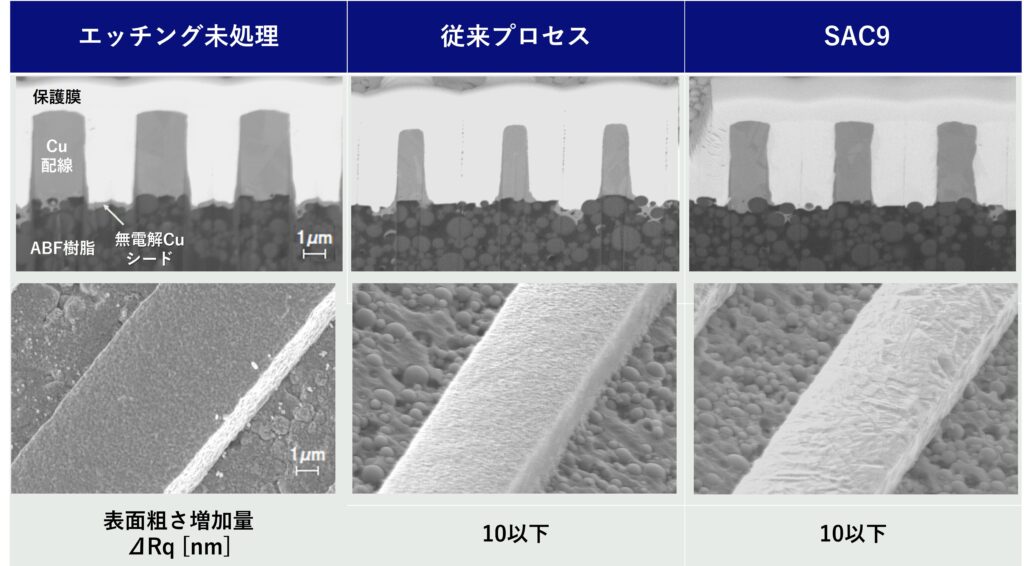
(ABF樹脂、無電解Cuめっきシード層0.3μm)
さらに、SAC9のエッチング量を増加させた場合の配線断面観察結果を図3に示す。エッチング量を増加させて過剰エッチングした場合においても、配線剝離が生じておらず、高いアンダーカット抑制性能を有することが確認できる。

(ABF樹脂、無電解Cuめっきシード層0.3μm)
■連続稼働時の安定性
SAC9は、連続稼働によるCu溶解に対して、添加剤の定量的な補給を実施することにより、安定して性能を維持することが可能なプロセスである。
SAC9の新規浴に対して、SAP基板を3m²B/L連続処理した浴(以下、連続処理浴)を用い、新規浴と連続処理浴の性能を比較した結果を図4に示す。また、その際のCuのエッチングレート(以下、E.R.)および表面粗さ増加量ΔRq、添加剤濃度の推移を図5に示す。なお、添加剤濃度については当社標準条件を100%とした場合の割合を示している。
図4に示す通り、連続処理浴においても、新規浴と同様にアンダーカットや配線幅に変動は生じない。また、図5に示す通り、Cu E.R.、表面粗さ増加量ΔRq、添加剤濃度においても一定の値をとり、高い安定性を有することが確認できる。
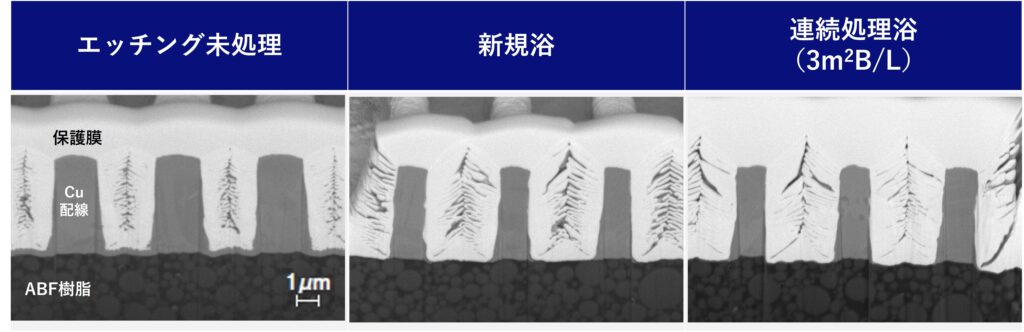
(ABF樹脂、無電解Cuめっきシード層0.3μm)
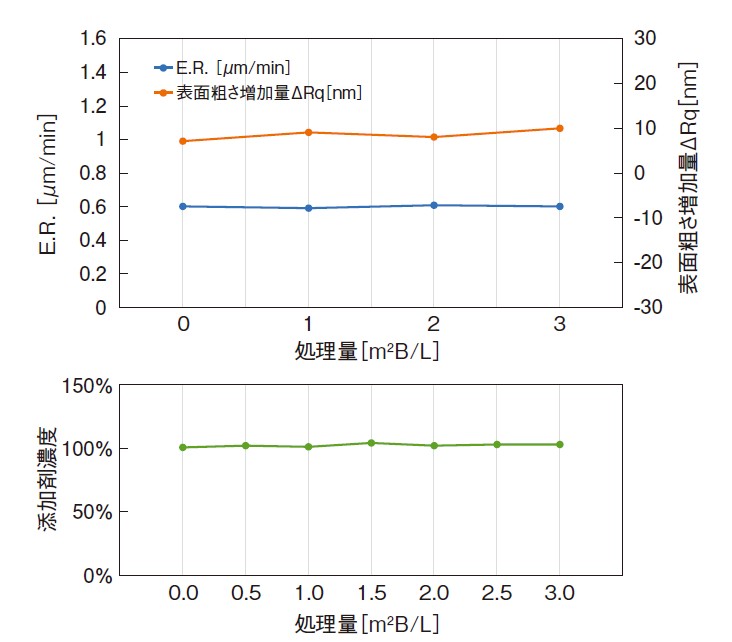
■スパッタシード層への適用
SAC9は、無電解Cuめっきシード層だけではなく、スパッタCuシード層にも適用することが可能なプロセスである。
Ti/Cuスパッタシード層(Tiスパッタ層100nm/Cuスパッタ層200nm)のSAP基板について、Cuスパッタ層をSAC9と従来プロセス、Tiスパッタ層をTiエッチング液で処理した際の断面および配線表面の観察結果を図6に示す。
いずれのエッチングプロセスにおいても、L/S=2/2μmの配線形成が可能であるが、特にSAC9は従来プロセスと比べて、配線幅減少量が抑制されており、Cuスパッタシード層を用いた基材に対しても優れたアンダーカット抑制性能を有することが確認できる。
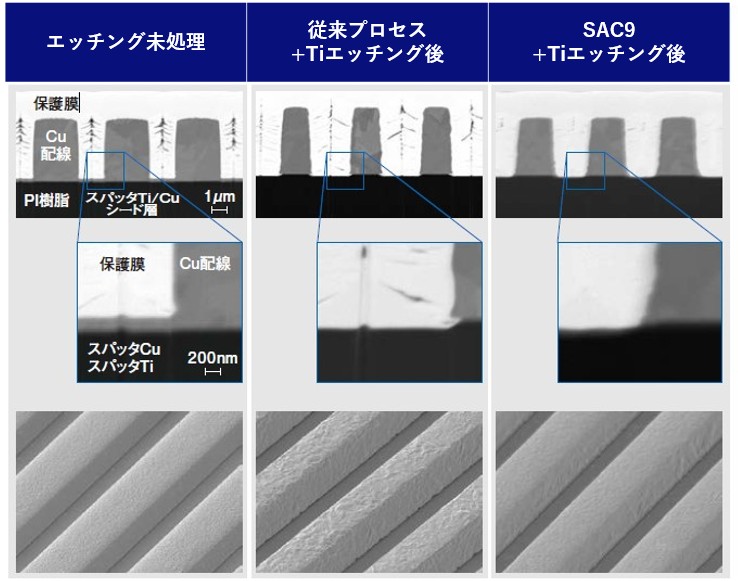
(PI樹脂、Ti/Cuスパッタシード層0.3μm)
おわりに
NEZARK® SAC9は、配線の微細化におけるシード層エッチングの課題である、配線幅減少量の低減、アンダーカットの低減、エッチング後の表面粗さ増加の抑制に対応したシード層エッチングプロセスである。無電解Cuめっきシード層のみならず、Ti/Cuスパッタシード層のスパッタCuに対しても適用可能なため、さらなる微細化が要求される、ハイエンドパッケージ、5G/6G関連など幅広い領域への適用が期待できる。




