プリント基板用硫酸銅めっき向け酸性クリーナー PB-281
総合研究所 電子技術開発部 長野 暢明 Nobuaki NAGANO 佐藤 麻里 Mari SATO
はじめに
近年、電子機器の小型化高密度化を目的として、微細化に有利なSemi Additive Process/Modified Semi AdditiveProcess(以下、SAP/MSAP)を採用する半導体パッケージ基板が増加している。SAP/MSAP工法では、Cuシード層上にドライフィルムレジストを用いて配線パターンを作製し、硫酸銅めっきを行うことでCu配線を形成する。
配線部の微細化に伴い、酸化被膜などの残渣除去が困難になることから、Cuシード層と硫酸銅めっきの界面に極小ボイドが多発することがある。これによりCu配線が倒れるなどの接続信頼性低下が懸念される。
そこで当社では、簡易に極小ボイドを低減する処理として、酸性クリーナーによる残渣の除去を提案している。酸性クリーナーは硫酸銅めっき前に基板に付着した油脂や酸化膜を除去するために使用される。これまで、当社ではドライフィルムレジストへの低アタック性や低発泡性などの機能を付与した酸性クリーナーを開発してきた。
本稿ではCuシード層とCuめっき界面のボイドを低減する機能を付与した酸性クリーナーPB-281を紹介する。
特長
- 効果的なCu、Cu合金の酸化被膜などの残渣除去が可能
- Cuシード層とCuめっき界面の極小ボイドを低減
- ドライフィルムレジストに対するダメージを低減
- 低発泡性のため作業性良好
- 硫酸銅めっき(後工程)への影響なし
性能
PB-281の性能としてCuシード層/Cuめっき界面の断面観察やドライフィルムレジストへのダメージ、発泡性を評価した。評価基板は株式会社レゾナック殿にご提供いただいた。
前処理として従来プロセスおよびPB-281の標準使用条件で脱脂処理を行い、硫酸銅めっき処理したSAP基板のCuシード層/Cuめっき界面の断面SEM像を図1に示す。
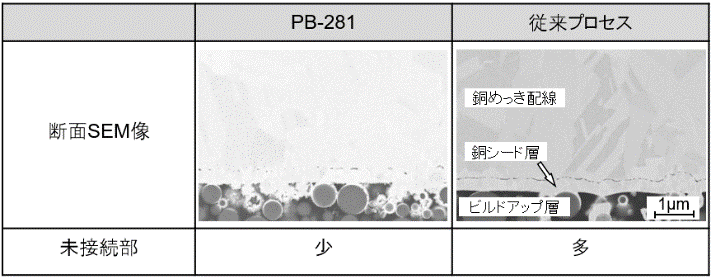
従来プロセスではCuシード層とC uめっきの界面に極小ボイドが発生し、未接続部が観察された。一方、PB-281では極小ボイドが低減し未接続部が大きく減少したことが確認できる。結果から、PB-281でめっき前処理を行うことで接続信頼性の向上が期待できる。
ドライフィルムレジストへのダメージ評価結果を図2に示す。評価基板(L/S=5/5μm)を従来プロセスとPB-281にそれぞれに長時間浸漬したところ、従来プロセスではドライフィルムレジストの剝離による蛇行が発生したが、PB-281では正常な状態の維持が確認された。したがって、PB-281はドライフィルムレジストへの影響が少なく、高密度化に伴う配線の微細化に対応可能と考えられる。
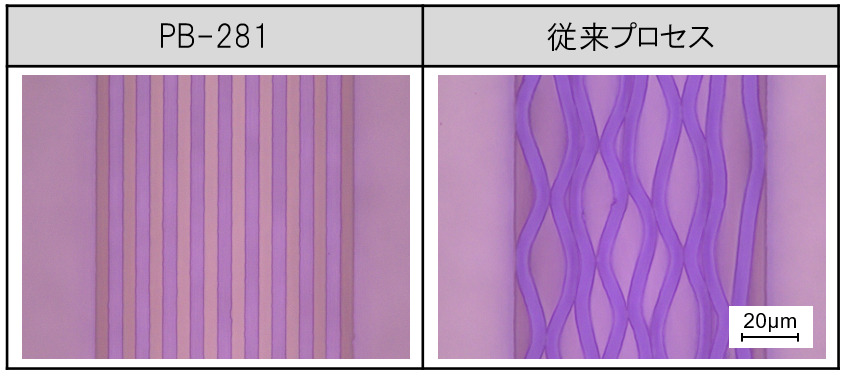
図3に従来プロセスとPB-281の発泡性の比較を示す。PB-281は従来プロセスと比較し、発泡性を抑制したことで、酸性クリーナーの飛散による作業環境の悪化を防止できる。
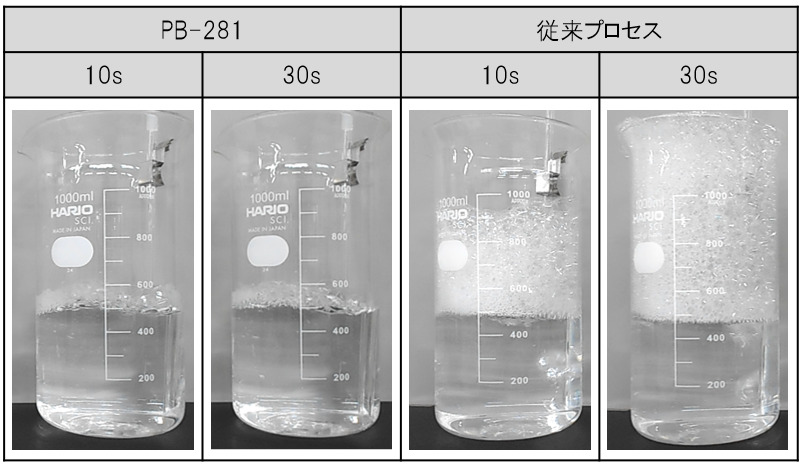
おわりに
PB-281は従来の酸性クリーナーに求められる性能に加えて、低発泡、ドライフィルムレジスト低ダメージおよびCuシード層とCuめっきの界面の極小ボイド低減という機能性を付与した酸性クリーナーである。
今後さらに進むであろう配線の微細化に対応し、接続信頼性の向上に寄与できるプロセスであると期待している。




