
Library JCUライブラリ
JPCA展示会のお知らせ
JCUについて
このたび弊社は、2025年6月4日から6日にかけてJPCA show 2025に出展することとなりました。今回は展示を予定しているSAP用硫酸銅めっきプロセス「CU-BRITE VF8」とSAP用回路形成エッチングプロセス「NEZARK SAC7」についてご紹介させていただきます。
いずれのプロセスもSAP(Semi-Additive Process:セミアディティブプロセス)向けの表面処理薬品であり、近年AIなどの技術進歩に伴い、高密度、高機能化といった要求が高まる半導体パッケージ基板の製造に適したプロセスとなっています。
① SAP用硫酸銅めっきプロセス 「CU-BRITE VF8」
「CU-BRITE VF8」はSAP用硫酸銅めっきプロセスです。SAP工法は、絶縁基板上に「シード層」※1という極薄の銅被膜を形成後、非配線部をドライフィルムレジストにより保護し、露出したシード層上に銅めっきで配線を形成し、ドライフィルムレジストの剥離後、余分なシード層を除去することで微細配線を形成する技術です。
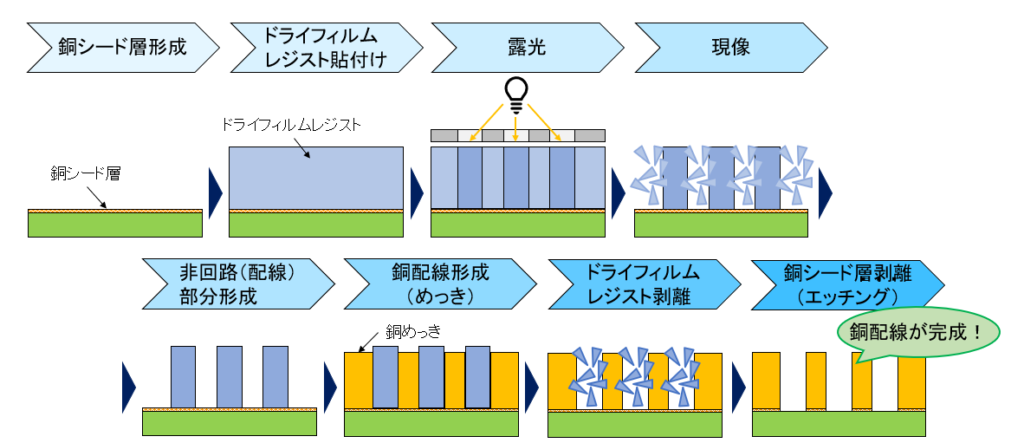
全面に銅めっきを行い、配線としたい部分以外の銅を除去(=エッチング)するサブトラクティブ法と異なり、SAPは必要な配線部分のみに銅めっきを行うため、エッチングが少量で済み、微細配線形成や銅の使用量を削減できるメリットがあります。一方、銅めっきを行う際に被膜の厚さが不均一になりやすく、高い制御能力が求められる技術でもあります。
「CU-BRITE VF8」の特長として、①高い硫酸濃度でのフィリング性※2※3(めっきの埋まり度合い)と膜厚均一性の両立②様々なサイズのBVH(ブラインドビアホール)※4と幅広い電流密度への対応③連続稼働性の3点が挙げられます。
SAP基板におけるめっき膜厚の均一性は、めっき液の硫酸濃度を上げ、イオン濃度を調節し、液中の導電性を高めることで改善が見込めます。しかし、硫酸濃度を上げるとBVH のフィリング性が低下する点が課題でした。また同時に、めっき時間の短縮のために電流密度を高めると、フィリング性が低下しやすいという問題も発生していました。
これらの課題に対し、「CU-BRITE VF8」は高い硫酸濃度や電流密度の環境下であってもフィリング性を維持したままめっきを行うことが可能であり、めっき時間の短縮を実現させました。また、BVHに対しても高いフィリング性能を有し、様々な大きさのBVHに対しても均一な膜厚を保持します。さらに、めっき液を長期にわたりご使用いただいた際にも、上記性能を維持することが確認されました。以上のことより、「CU-BRITE VF8」は性能面、生産面ともに優れ、SAPに適した硫酸銅めっきプロセスとなっています。
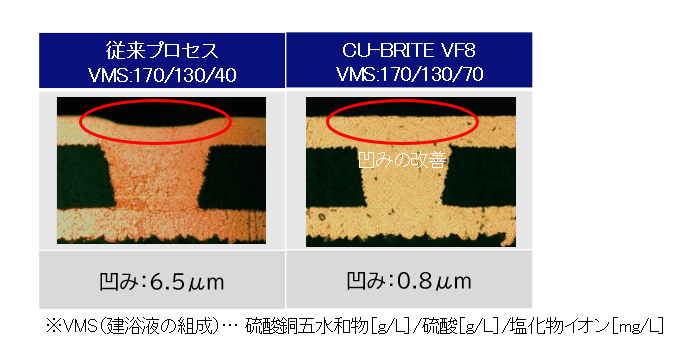
② SAP用回路形成エッチングプロセス 「NEZARK SAC7」
「NEZARK SAC7」はSAP用回路形成エッチングプロセスです。エッチングとは、素材の表面を薬品やプラズマによって腐食させ、除去する加工方法です。今回ご紹介するエッチングプロセスは、銅めっきで配線を形成後、ドライフィルムレジストを剥離した際に露出するシード層を除去することで、配線をかたどることができます。エッチングは繊細なデザインの配線形成に向いており、半導体パッケージ製造において重要な処理です。
「NEZARK SAC7」の特長として①エッチングの際のアンダーカットの抑制②銅配線表面の平滑性維持③連続稼働性の3点が挙げられます。
エッチングは素材表面に対し、腐食が垂直方向のみならず横方向からも進行するため、銅めっきで形成した配線が横に崩れてしまう現象(=アンダーカット)が発生しやすい特徴があります。特に幅の狭い配線の場合、アンダーカットが生じた際の影響が大きく、配線剝離の原因となってしまいます。またエッチングの別の課題として、エッチングの反応速度のばらつき等の要因で腐食の程度に差が生じ、銅配線の表面の平滑性(なめらかさ)が失われる点が挙げられます。配線表面の平滑性の低下は伝送損失※5にもつながります。
これらの課題に対し、「NEZARK SAC7」は、高いアンダーカット抑制性能を発揮し、エッチング後の平滑性低下の問題も従来プロセスより大きく改善されたプロセスとなっています。また、長期的な稼働においても安定したエッチング性能を有します。以上のことから、「NEZARK SAC7」は微細な半導体チップ※6を搭載する高機能電子機器向け半導体パッケージ基板の製造に適したSAP用エッチングプロセスとなっています。
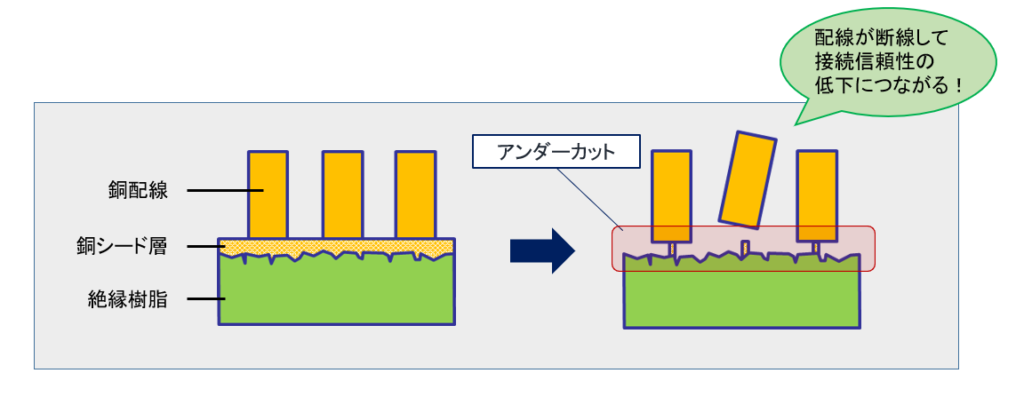
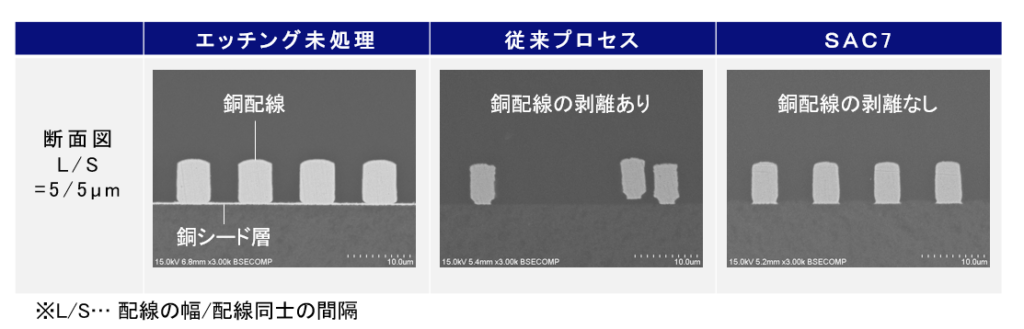
今回ご紹介した「CU-BRITE VF8」と「NEZARK SAC7」は、AIやBeyond 5Gといった技術の発展に伴い、高度化が進む半導体パッケージ基板の製造に活用できるプロセスであり、次世代半導体パッケージング技術の進歩に貢献できるプロセスとなっています。
上記でご紹介した他にも、MSAP(Modified Semi-Additive Process:モディファイドセミアディティブプロセス)用高面均性スルーホールフィリングめっきプロセス「CU-BRITE TF8」など、当社の主力技術であるビアフィリング※7薬品を多数ご用意しており、こちらも高速・大容量通信デバイス用基板向けに適した製品となっています。その他複数の製品ラインナップの展示を行っておりますので、この機会にぜひご来場ください。
※1 シード層…絶縁体の樹脂上にめっき技術を用いて銅配線を形成する際に必要となる薄い金属層
※2 フィリング…電気を流せるようにするために、基板に開いた穴に銅を充填すること
※3 硫酸銅めっき…電気を用いて、金属等の素材の表面に銅の被膜を形成するめっき
※4 BVH…層同士を銅配線で接続するための表面層から中間層まで空いた穴のこと
※5 伝送損失…通信経路を流れる電気や光の信号が距離によって減衰すること
※6 半導体チップ…メモリやロジックIC(集積回路)などを組み合わせてパッケージングされた半導体集積回路の総称
※7 ビアフィリング…基板の層間に開いた穴を金属めっきで埋めること
JPCA Show 2025
- 会期
-
2025年6月4日(水)~6月6日(金)
- 会場
-
東京ビッグサイト東 4~6ホール
- ブース番号
-
5H-03
<JPCA Show2025(電子機器トータルソリューション展)>公式サイト
https://www.nepconjapan.jp/tokyo/ja-jp/visit.html
※来場登録はこちらからよろしくお願いいたします。
本件の問い合わせ先
株式会社 JCU 経営戦略室 経営企画部
TEL:03-6895-7004 E-mail:kikaku@jcu-i.com




